Z 4504:2008 (ISO 7503-1:1988)
(1)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
目 次
ページ
序文 ··································································································································· 1
1 適用範囲 ························································································································· 1
2 引用規格 ························································································································· 1
3 用語及び定義 ··················································································································· 2
4 放射性表面汚染の測定方法 ································································································· 3
4.1 一般 ···························································································································· 3
4.2 直接測定法 ··················································································································· 4
4.3 間接測定法 ··················································································································· 5
5 機器効率の決定 ················································································································ 6
6 測定の記録 ······················································································································ 7
附属書A(規定)校正及び測定にかかわる基本的事項及びデータ ··················································· 9
Z 4504:2008 (ISO 7503-1:1988)
(2)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
まえがき
この規格は,工業標準化法第14条によって準用する第12条第1項の規定に基づき,社団法人日本電気
計測器工業会(JEMIMA)及び財団法人日本規格協会(JSA)から工業標準原案を具して日本工業規格を改正す
べきとの申出があり,日本工業標準調査会の審議を経て,経済産業大臣が改正した日本工業規格である。
これによって,JIS Z 4504:1993は改正され,この規格に置き換えられた。
この規格は,著作権法で保護対象となっている著作物である。
この規格の一部が,特許権,出願公開後の特許出願,実用新案権又は出願公開後の実用新案登録出願に
抵触する可能性があることに注意を喚起する。経済産業大臣及び日本工業標準調査会は,このような特許
権,出願公開後の特許出願,実用新案権又は出願公開後の実用新案登録出願に係る確認について,責任は
もたない。
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
日本工業規格 JIS
Z 4504:2008
(ISO 7503-1:1988)
放射性表面汚染の測定方法−
β線放出核種(最大エネルギー0.15 MeV以上)
及びα線放出核種
Evaluation of surface contamination-Beta-emitters (maximum beta energy
greater than 0.15 MeV) and alpha-emitters
序文
この規格は,1988年に第1版として発行されたISO 7503-1を基に,技術的内容及び対応国際規格の構
成を変更することなく作成した日本工業規格である。
1
適用範囲
この規格は,物品,施設,線源収納容器,密封線源など(以下,“物品など”という。)の放射性表面汚
染を表面汚染密度で評価する方法について規定する。ただし,皮膚及び衣服については,適用しない。
この規格は,最大エネルギーEβmaxが0.15 MeV以上のβ線放出核種及びα線放出核種による放射性表面
汚染に適用する。厳密には,1壊変当たりに生成されるβ粒子,単色電子,又はα粒子の数が,ほぼ1個
であるとみなせる核種に限定される(表A.3参照)。
注記 この規格の対応国際規格及びその対応の程度を表す記号を,次に示す。
ISO 7503-1:1988,Evaluation of surface contamination−Part 1: Beta-emitters (maximum beta energy
greater than 0.15 MeV) and alpha-emitters (IDT)
なお,対応の程度を表す記号(IDT)は,ISO/IEC Guide 21に基づき,一致していることを示す。
2
引用規格
次に掲げる規格は,この規格に引用されることによって,この規格の規定の一部を構成する。これらの
引用規格は,その最新版(追補を含む。)を適用する。
JIS Z 4001 原子力用語
注記 対応国際規格:ISO 921:1997,Nuclear energy−Vocabulary,IEC 60050-393:1996,International
Electrotechnical Vocabulary−Chapter 393,IEC 60050-394:1995,International Electrotechnical
Vocabulary−Chapter 394(全体評価:MOD)
JIS Z 4329 放射性表面汚染サーベイメータ
注記 対応国際規格:IEC 60325,Radiation protection instrumentation−Alpha, beta and alpha/beta (beta
energy > 60 keV) contamination meters and monitors (MOD)
JIS Z 4334 放射性表面汚染モニタ校正用線源−β線放出核種(最大エネルギー0.15 MeV以上)及び
α線放出核種
2
Z 4504:2008 (ISO 7503-1:1988)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
注記 対応国際規格:ISO 8769,Reference sources for the calibration of surface contamination monitors
−Beta-emitters (maximum beta energy greater than 0.15 MeV) and alpha-emitters (MOD)
3
用語及び定義
この規格で用いる主な用語及び定義は,JIS Z 4001によるほか,次による。
3.1
放射性表面汚染(surface contamination)
物品などの表面の放射性汚染。
3.2
固定性表面汚染(fixed surface contamination)
通常の作業状況で放射性物質が,物品などの表面から遊離しない状態の放射性表面汚染。
3.3
遊離性表面汚染(removable surface contamination)
通常の作業状況で放射性物質が,物品などの表面から遊離する状態の放射性表面汚染。
注記1 “通常の作業”の定義は,放射性表面汚染から放射性物質を吸入するリスクの評価に重要で
ある。放射性表面汚染との物理的接触のうちで,“通常の作業”とみなせる最大の接触強さの
例として,次のものがある。
− 人体と放射性表面汚染との間で日常的に起こる,事故でない接触(衣服を介する間接的
な場合と直接皮膚が触れる場合とがある。)。
− 人が通常の力で器具を用いて物を取り扱うとき(破壊的な作業は除く。)の器具と物の表
面との接触。
ふき取り試験のふき取る強さは,このような通常の作業における接触の強さと同等である
ことが望ましい。通常,1回のふき取りで遊離性表面汚染の全部をふき取ることはない。
注記2 人為的行為がなくても,湿度,化学薬品などの影響によって,又は腐食,拡散などの過程を
経て,固定性表面汚染が遊離性表面汚染に変化することがある。また,その逆の現象も起こ
り得るし,蒸発及び揮発によって放射性表面汚染の放射能が減少することもある。
3.4
表面汚染密度(activity per unit area)
放射性表面汚染の放射能の汚染面積に対する比。単位は,Bq・cm−2で表す。
3.5
直接測定法(direct measurement of surface contamination)
放射線測定器を用いて固定性表面汚染及び遊離性表面汚染を直接的に測定する方法。この方法は,物品
などの内部に収納された放射性物質からの放射線,又は周囲の放射線の影響を受けることがある。
3.6
間接測定法(indirect evaluation of surface contamination)
ふき取り試験によって,遊離性表面汚染を間接的に測定する方法。
3.7
ふき取り試験(smear test)
ふき取りろ紙又はふき取りろ紙以外の採取材(以下,“ふき取りろ紙など”という。)を用いて物品など
の表面をふき取り,ふき取りろ紙などに移行した放射能から遊離性表面汚染を評価する試験。ふき取りろ
3
Z 4504:2008 (ISO 7503-1:1988)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
紙などを適切な液体で湿らせてふき取る方法(以下,“湿式ふき取り試験”という。)と乾燥したふき取り
ろ紙などを用いてふき取る方法(以下,“乾式ふき取り試験”という。)とがある。
3.8
ふき取り効率 F(removal factor)
ふき取り試験において,1回のふき取りによってふき取られた放射能のふき取る前の遊離性表面汚染の
放射能に対する比で,次の式による。
T
p
A
A
F=
ここに, Ap: 1回のふき取り試験でふき取った放射能
AT: ふき取りを行う前に存在した遊離性表面汚染の放射能
注記 何回もふき取り試験を繰り返すことによって,実験的にふき取り効率Fを求めることができる。
複数回のふき取り試験でふき取った放射能を合算することによって,遊離性表面汚染の放射能
(AT)を精度よく推定することができ,最初のふき取り試験でふき取った放射能(Ap)との比
からふき取り効率Fを算出することができる。
3.9
表面放出率 q2π(surface emission rate of a source)
線源の前方表面から単位時間に放出される,あるエネルギー以上のβ粒子又はα粒子の数。
3.10
線源効率 ε S(efficiency of a source)
表面放出率の線源(飽和層厚さ以上の厚さの線源は飽和層)の中で単位時間に放出される同じ種類の放
射線粒子数に対する比。
3.11
機器効率 ε i(instrument efficiency)
線源に対して,決められた幾何学的条件で測定したときの測定器の正味計数率と線源の表面放出率との
比。ある特定の放射線測定器の機器効率は,放射線のエネルギーに依存する。
注記 3.9及び3.10の定義から,表面放出率は,放射能と線源効率ε Sとの積となる(A.1参照)。
4
放射性表面汚染の測定方法
4.1
一般
放射性表面汚染は,直接測定法及び間接測定法によって測定する。直接測定法では,通常,放射線測定
器を用いて遊離性表面汚染と固定性表面汚染とを同時に測定する。間接測定法では,通常,ふき取り試験
によって遊離性表面汚染だけを測定する。
放射性表面汚染を測定する目的は,次の二つである。
a) 放射性表面汚染の有無及び汚染の範囲を特定し,高いレベルの汚染区域から低いレベルの汚染区域又
は非汚染区域への汚染の拡大を防止する。
b) 単位面積当たりの放射能を評価して,表面密度限度などの判定基準以下であるか,超えているかを確
認する。
直接測定法か間接測定法かの選択は,放射性表面汚染の物理的及び化学的形状,物品などの表面との付
着状態(固定性表面汚染又は遊離性表面汚染),放射線測定器を測定点に近づけることの可否,妨害となる
4
Z 4504:2008 (ISO 7503-1:1988)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
外部放射線の有無などによる。
間接測定法は,放射線測定器を測定点に近づけることが物理的に困難な場合,又は外部放射線量が高い
場合に,有効な方法である。間接測定法では,固定性表面汚染を測定することはできない。また,ふき取
り効率に起因する不確かさも決して小さいものではないが,遊離性表面汚染の測定に有効である。
直接測定法及び間接測定法のいずれにも欠点があり,よりよい結果を得るためには両者を併用すること
が望ましい。
機器効率は放射線エネルギーに依存するため,複数のβ線放出核種による混合汚染の場合には,注意し
なければならない(箇条5参照)。放射能を直接表示する放射線測定器を用いる場合には,特に注意が必要
である。
なお,校正及び測定にかかわる基本的事項及びデータは,附属書Aによる。
4.2
直接測定法
4.2.1
放射線測定器に対する要求事項
放射性表面汚染の測定に用いる放射線測定器の特性及び性能は,JIS Z 4329に合致したものでなければ
ならない。
放射線測定器は,表面密度限度などの判定基準以下の汚染レベルを測定できるものでなければならない。
注記1 この規格では,検出限界放射能を求める具体的計算方法については規定しない。
注記2 直接測定法に用いる放射線測定器の有効性は機器効率だけでなく,有効面積の大きさにもよ
る。大面積の窓をもつ放射線測定器は,広範囲にわたって汚染を測定するときなどに有効で
ある。
4.2.2
検出方法
測定面上をゆっくりと,検出器を移動させながら測定する。汚染を検出した場合は,その場所に検出器
を十分な時間,静止させて測定する。検出器と測定面との距離は,検出器が汚染しない程度にできる限り
近づける。距離を一定に保持するためにスペーサなどを用いてもよい。
4.2.3
測定方法
4.2.3.1
測定するときは,放射線測定器の取扱説明書及び次の事項に従わなければならない。
a) 測定場所におけるバックグラウンド計数率をあらかじめ測定する。
b) バックグラウンド計数率は,測定中も適宜,確認する。
c) 放射線測定器が正常に動作することを,測定頻度が高い場合には毎日,そうでない場合には測定の都
度,適切な確認用線源を用いて確認することが望ましい。確認の結果,基準値との差が25 %を超え
た場合は,再校正しなければならない。
d) 実際に放射性表面汚染を測定する場合の幾何学的条件は,校正時の条件と可能な限り同一にすること
が望ましい。そのために,着脱式のスペーサを用いてもよい。
e) 精度よく測定する場合には,検出器を時定数の3倍の時間(95 %指示に相当)静止させた後,指示値
を読み取る。
f)
機器効率は,対象とする核種に対して十分高いものでなければならない(箇条5参照)。
4.2.3.2
固定性表面汚染及び遊離性表面汚染の表面汚染密度AS(Bq・cm−2)は,式(1)による。ただし,汚
染面積は,放射線測定器の有効窓(入射窓)面積と同等又は広いものとし,有効窓面積における表面汚染
密度は均一とみなす。
S
i
B
s
ε
ε
×
×
−
=
W
n
n
A
········································································· (1)
5
Z 4504:2008 (ISO 7503-1:1988)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
ここに, n: 総計数率(s−1)
nB: バックグラウンド計数率(s−1)
εi: β粒子又はα粒子に対する機器効率(箇条5及びA.2参照)
W: 放射線測定器の有効窓面積(cm2)
ε S: 放射性表面汚染の線源効率(A.1参照)
εsの値が明らかでない場合は,安全側の数値として,次の値を用いることが望ましい(A.1参照)。
ε S=0.5 [β線放出核種(Eβmax≧0.4 MeV)]
ε S=0.25 [β線放出核種(0.15 MeV<Eβmax<0.4 MeV)及びα線放出核種]
α線放出核種の場合は,この値を用いると過小評価になる可能性がある(A.1参照)。
必要に応じて,得られる計数率に不感時間の補正をすることが望ましい。
逐次壊変するα線放出核種が平衡状態にある場合には,平衡状態にあるすべてのα線放出核種の全放射
能を測定することになる。完全に平衡状態に達している場合は,全放射能を平衡状態にある核種の数で除
した値が一つのα線放出核種の放射能となる。
平衡状態にあるβ線放出核種についても同様であるが,親核種及び子孫核種に対する機器効率が同程度
の場合に限る(表A.3の注記参照)。
表A.3の補足欄に§印を付した放射平衡核種については,核種欄に下線を付した核種だけが検出される。
これらが平衡状態にある場合の全放射能は,算出した放射能の2倍となる。
注記 自動演算機能を備えた放射線測定器は,nB,W,ε i 及びε Sの値を記憶させることによって,単
位面積当たりの放射能を自動的に表示することができる。ε i 及びε Sは,核種と放射性表面汚染
との状況によって決まる値であり,それぞれ適切な値を選択できなければならないが,一般的
には,選択できないパラメータとして機器のメモリに記憶されている。ただし,このような放
射線測定器を箇条5の注記5に従って校正した場合には,ε Sの値だけが選択できればよいこと
になる。
4.3
間接測定法
4.3.1
放射線測定器に対する要求事項
ふき取り試料は,パルス計測形の固定式測定器を遮へい体で囲って測定することが一般的である。放射
性表面汚染サーベイメータを用いる場合には,その特性及び性能は,JIS Z 4329に合致しなければならな
い。
放射線測定器は,表面密度限度などの判定基準以下のレベルを測定できなければならない(4.2.1の注記
1参照)。
4.3.2
ふき取り試料の採取方法
湿式ふき取り試験又は乾式ふき取り試験のいずれかの方法で行う。
広い面積をふき取る場合には,次の事項を考慮しなければならない。
a) ふき取り面積は,できるだけ100 cm2とすることが望ましい。
b) 法規制などで,放射性表面汚染の評価を100 cm2より広い面積の平均でよいとしている場合には,そ
の面積をふき取ってもよい。
c) ふき取りろ紙などは,試験する物品などの表面の状態に合うものを選ぶことが望ましい(例えば,平
滑な表面にはふき取りろ紙,平滑でない表面には綿布など。)。
d) 湿式ふき取り試験の場合は,ふき取りろ紙などから用いた液体がにじみ出ないことが望ましい。
警告 α線放出核種に対して湿式ふき取り試験を行うと,放射性表面汚染がふき取りろ紙などの中に
侵入したり,ふき取りろ紙などが残存水分で覆われたりするため,過小評価になることがある。
6
Z 4504:2008 (ISO 7503-1:1988)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
e) 物品などの表面を適切な強さの力でふき取る。ふき取りろ紙などを直接指で押さえてふき取ってもよ
いが,ホルダのようなジグを用いることによって,均一で一定の力となることが望ましい。
f)
100 cm2の全面積を一様にふき取る。
g) ふき取りろ紙などは,特に問題がなければ,円形のふき取りろ紙を用いることが望ましい。
h) ふき取りろ紙などにおけるふき取り部の面積は,検出器の有効面積と等しいか,又は小さくなければ
ならない。
i)
試料採取の後,ふき取りろ紙などが水分を含んでいる場合は,放射能の損失に注意しながら乾燥する。
4.3.3
測定方法
ふき取り試料は,4.2.3.1の方法で測定することが望ましい。
ふき取った表面の単位面積当たりのβ線放出核種又はα線放出核種の遊離性表面汚染の放射能Asr(Bq・
cm−2)1) は,式(2)による。
S
i
B
sr
ε
ε
×
×
×
−
=
S
F
n
n
A
··································································· (2)
ここに, n: 全計数率(s−1)
nB: バックグラウンド計数率(s−1)
ε i: β粒子又はα粒子に対する機器効率(箇条5及びA.2参照)
F: ふき取り効率
S: ふき取り面積(cm2)
ε S: ふき取り試料の線源効率(A.2参照)
注1) 式(2)を適用できる核種は,箇条1で規定した核種に限る。
ふき取り試料の線源効率ε Sは,4.2.3.2の値を用いることが望ましい。
ふき取り効率Fは,実験的評価がある場合にはその値を,実験的評価がない場合には安全を考慮して0.1
を用いなければならない。
平衡状態にある核種については,4.2.3.2を参照する。
5
機器効率の決定
機器効率は,単位面積当たりの放出率について校正したJIS Z 4334に規定する標準線源を用いて校正し
なければならない。
標準線源の放射能面積は,検出器窓を十分に覆う大きさであることが望ましい。大面積の標準線源がな
い場合には,少なくとも100 cm2の放射能面積をもつ比較的小さい面積の標準線源を用いて分割測定をす
る。分割測定の場合には,有効窓面積の全体にわたって測定することが望ましいが,代表的な部分につい
て測定する方法でも差し支えない。いずれの方法でも機器効率ε iは,測定結果の平均値から求める。
α粒子に対する機器効率及びβ粒子に対する機器効率,それぞれについて校正しなければならない。
いずれの場合も,測定時に吸収を受け,例えば,α線は,線エネルギースペクトルが連続スペクトルの
ように広がるなどの影響がある。このように,実際の放射性表面汚染に対する放射線測定器の機器効率は,
薄層の標準線源に対する機器効率より一般的に小さくなる。
β粒子に対する機器効率ε iは,β線エネルギーに依存するので,実際の放射性表面汚染から放出される
β線のエネルギーに対応した機器効率を求めることが望ましい。β線エネルギーの異なる複数の核種を使
用する施設でも,実際は,特定のβ線エネルギーに対する機器効率だけで測定しているところが多いが,
このような場合は,校正に用いる標準線源のβ線エネルギーは,測定対象とする核種の中の最も低いβ線
エネルギーと比較して,極端に高いものであってはならない。
7
Z 4504:2008 (ISO 7503-1:1988)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
次に示すβ線放出核種が,標準線源の核種に適している。
14C
(Eβmax=0.154 MeV)
147Pm
(Eβmax=0.225 MeV)
36Cl
(Eβmax=0.71 MeV)
204Tl
(Eβmax=0.77 MeV)
90Sr/90Y
(Eβmax=2.26 MeV)
106Ru/106Rh (Eβmax=3.54 MeV)
機器効率を校正するときの幾何学的条件は,直接測定法又は間接測定法で実際に放射性表面汚染を測定
するときの幾何学的条件にできる限り近いものにしなければならない(4.2.3.1参照)。
機器効率ε iは,式(3)による(A.2参照)。
W
E
n
n
q
n
n
×
−
=
−
=
SC
B
SC
,π
2
B
iε
·································································· (3)
ここに,
n: 標準線源による全計数率(s−1)
nB: バックグラウンド計数率(s−1)
q2π,SC: 検出器の有効窓面積W(cm2)の部分における標準線源の表
面放出率(s−1)
ESC: 標準線源の単位面積当たりの表面放出率(s−1・cm−2)
注記1
90Srが90Yと平衡状態にある場合には,標準線源の単位面積当たりの表面放出率ESCは,90Sr
だけに着目した単位面積当たりの表面放出率の2倍である。
注記2 標準線源の表面放出率が不明の場合,すなわち,標準線源がJIS Z 4334の規定を満足してい
ない場合は,A.4.1に基づいて,ESCを推定することができる。
注記3 薄層の標準線源を用いて校正するよりも飽和層厚さの標準線源を用いて校正する方が,機器
効率は,安全側の値となる。
注記4 自動演算機能を備えた放射線測定器の中には,次の方法でε iを決定できるものがある。
単位面積当たりの表面放出率(ESC)で校正した,十分に広い面積の標準線源の上方に検出
器を置き,放射線測定器の校正定数を連続的に変化させて計数率計の指示がESCの値に一致
するように合わせる。これによって,放射線測定器は,その条件下における機器効率ε iに等
しい校正定数をもつことになる。
注記5 自動演算機能を備えた放射線測定器は,次の方法で校正を行うこともできる。
単位面積当たりの表面放出率(ESC)で校正した,十分に広い面積の標準線源の上方に検出
器を置き,放射線測定器の校正定数を連続的に変化させて計数率計の指示がESC /ε Sの値に一
致するように合わせる。ただし,ε Sは,実際の放射性表面汚染の線源効率である。
6
測定の記録
放射性表面汚染の測定報告書が必要な場合には,次の事項を記載することが望ましい。
a) 測定年月日
b) 測定場所及び測定箇所
c) 間接測定法の場合の表面状態
d) 間接測定法の場合のふき取りろ紙などの種類(乾式ふき取り法と湿式ふき取り法との区別)
e) 湿式ふき取り法の場合に用いた液体
f)
間接測定法の場合のふき取り効率(実験に基づいた値か否かの区別)
8
Z 4504:2008 (ISO 7503-1:1988)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
g) 放射線測定器の名称及び機器番号
h) 機器効率及び校正年月日
i)
校正に用いた標準線源:核種及び(単位面積当たりの)表面放出率
j)
放射線測定器の指示値(直接測定法又は間接測定法の区別)
k) バックグラウンド指示値
l)
放射性表面汚染の表面汚染密度
m) 放射性表面汚染の広がりに関する記述
n) その他の観察事項
o) 測定者の氏名
9
Z 4504:2008 (ISO 7503-1:1988)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
附属書A
(規定)
校正及び測定にかかわる基本的事項及びデータ
この附属書は,校正及び測定にかかわる基本的事項及びデータについて規定する。
A.1 一般
放射性表面汚染は,通常,表面汚染密度で評価する。しかし,放射線測定器で得られる計数率は,放射
性表面汚染の表面又は内部に含まれる放射能ではなく,線源の表面から放出される放射線に依存する。線
源の表面から放出される放射線粒子の数は,線源による自己吸収と線源及び物品(バッキング材など)に
よる後方散乱によって増減する。一般的に,自己吸収は放出粒子の数を減少させ,後方散乱は増加させる。
しかし,実際の汚染物では,吸収及び散乱の特性が一つ一つ異なるため,一般的に放出率と放射能との間
に簡単な関係式を導き出すことは難しい。これまでは標準線源の放射能(又は単位面積当たりの放射能)
に対してレスポンスを求めることが,一般的な放射線測定器の校正方法であったが,標準線源の放射能で
はなく,放出率から放射線測定器を校正することが必要である。このため,標準線源も放射能及び放出率
の両方で校正することが望ましい。
注記1 標準線源の単位面積当たりの放射能で校正した効率は,“放射能レスポンス”と表すこととし,
機器効率とは区別する。
放射能に基づいて校正定数を求めるには,自己吸収及び後方散乱がない理想的に薄い標準線源が必要で
ある。しかし,実際に入手できる標準線源は,特にα線放出核種及び低エネルギーβ線放出核種(最大エ
ネルギーが0.4 MeVより低い核種。)では,理想とはかけ離れている。放射能に基づいて校正した放射能
レスポンスは,放射線測定器に固有のものでなく,標準線源の構造に依存するものである。同一の核種,
同一の放射能であっても,異なる構造の標準線源を用いれば,校正定数も異なった値となる。これに対し
て,標準線源の放出率に基づいた校正定数は,標準線源の構造にそれほど依存しないため,個々の測定器
がもつ固有の検出感度を示すこととなる。このことは,測定器間の比較を容易にし,国家標準へのトレー
サビリティの確立を可能にする。
この附属書は,放出率に基づく校正と放射能に基づく校正との相違を明確にするとともに,混乱を避け
るため,放射性表面汚染の測定と放射線測定器の校正に関連した用語,特に機器効率ε i及び線源効率ε Sに
ついて示す。
注記2 ここでいう国家標準とは,JIS Z 8103に定義される国が認めた計量標準である。
A.2 用語の説明
表A.1に示す用語を図A.1に図解する。nは,得られる計数率で,線源からの放射線に起因する。q1〜
q6は,放射線粒子の生成率に関するもので,次による。
タイプ1:検出器に直接入射する粒子。
タイプ2:散乱によって検出器に入射する粒子。
タイプ3:線源から検出器側の立体角2 πsrの方向に放出されるが,空気の吸収によって検出器まで到
達しない粒子。
タイプ4:検出器側の立体角2 πsrの方向に向かって放射されるが,自己吸収で線源から放出されない
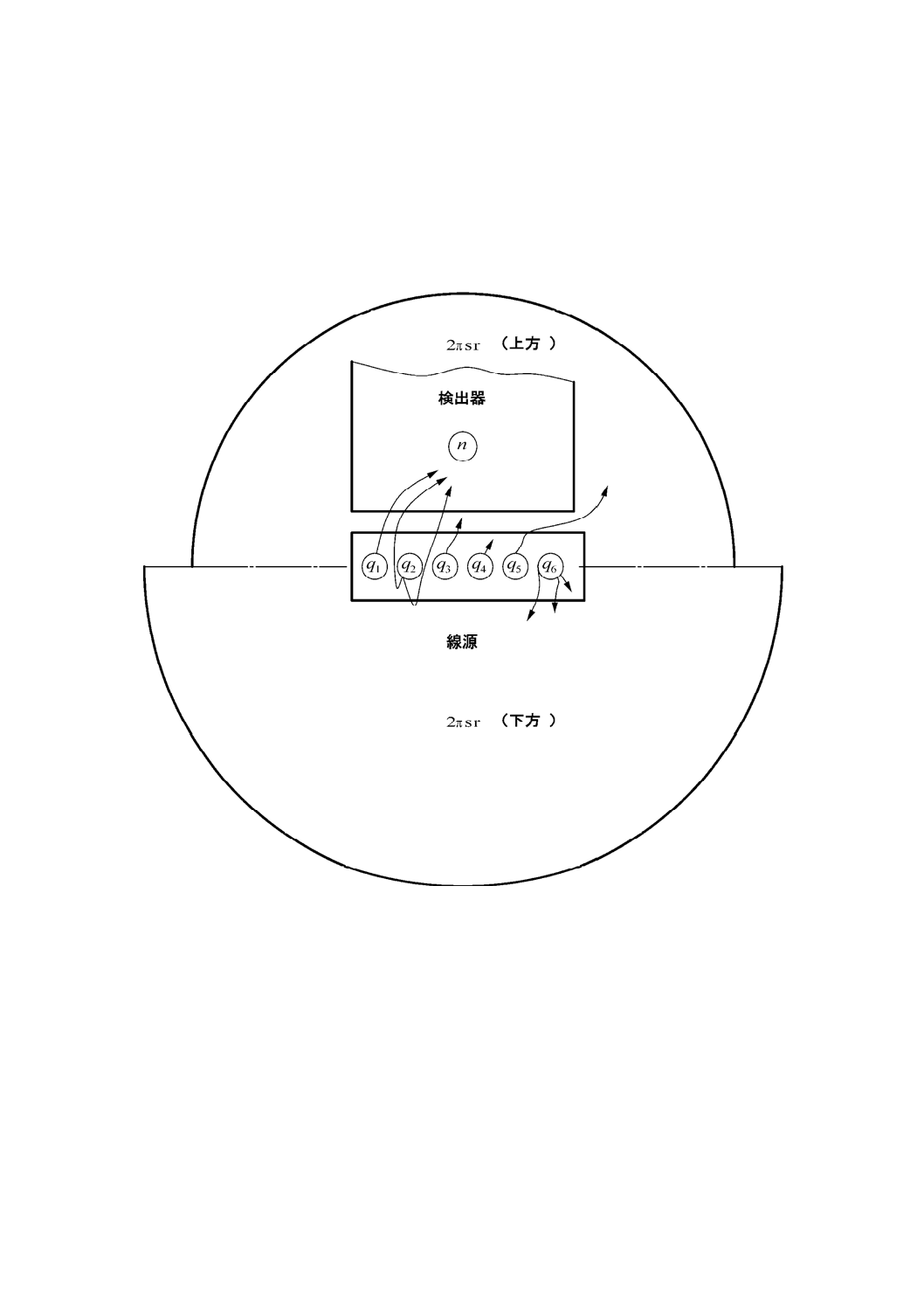
10
Z 4504:2008 (ISO 7503-1:1988)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
粒子。
タイプ5:線源から検出器側の立体角2 πsrの方向に放出されるが,幾何学的条件から検出器に入射し
ない粒子。
タイプ6:検出器と反対側の立体角2 πsrの方向に向かって放射されるすべての粒子。タイプ2以外の
後方散乱粒子を含む。
図A.1−線源と検出器との相関断面図
表A.1の定義欄のq1〜q6は,図A.1に示すタイプ1〜6の分類に対応している。
放射線測定器の固有効率Iiは,得られた計数率を単位時間に検出器に入射した粒子の数で除した商とし
て定義される。
自己吸収及び後方散乱がない理想的な線源に対する線源効率ε Sは,0.5であるが,通常は0.5より小さい。
ただし,自己吸収と後方散乱との関係から,0.5よりも大きくなることもある。
ε i及びI iの最大値は1である。

11
Z 4504:2008 (ISO 7503-1:1988)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
表A.1−用語の定義
用語
記号
単位
定義
線源の放射能a)
A
Bq
6
5
4
3
2
1
q
q
q
q
q
q
A
+
+
+
+
+
=
線源の表面放出率
q2π
s−1
5
3
2
1
π
2
q
q
q
q
q
+
+
+
=
線源効率
ε S
b)
A
q
q
q
q
q
q
q
q
q
q
q
ε
π
2
6
5
4
3
2
1
5
3
2
1
S
=
+
+
+
+
+
+
+
+
=
機器効率
ε i
b)
5
3
2
1
i
q
q
q
q
n
+
+
+
=
ε
固有効率
Ii
b)
2
1
i
q
q
n
I
+
=
放射能Aに対するレスポンス
Ri
b)
A
n
R
=
×
=
S
i
i
ε
ε
注a) ここでの放射能の定義は,箇条1に規定する核種に限って用いることができる。厳密には,放射能は,次の式
で定義することが望ましい。
)
q
q
q
q
q
q
(
A
6
5
4
3
2
1
d
1
+
+
+
+
+
=ε
ここに,εd:1壊変当たりに生成される着目粒子の数であるが,この規格が適用する核種
(表A.3参照)については,1として差し支えない。
b) 効率に関する次元は,すべて無次元である。
表A.1の定義によって,放射能Aに対する放射線測定器のレスポンスRiは,次の式で表すことができる。
S
i
i
ε
ε
R
×
=
すなわち,放射能に対するレスポンスRiは,機器効率ε i(放射線測定器の特性及び測定時の幾何学的条
件に依存する。)及び線源効率ε S(主に線源の基本的特性に依存する。)とに分割することができ,したが
って,標準線源の放射能に基づいて校正したときの校正定数Riは,放射線測定器及び標準線源の特性,並
びに幾何学的条件の組合せによって決まる。
A.3 機器効率
機器効率ε iは,β線の最大エネルギー又はα線エネルギーによって決まるものではなく,実際に放出さ
れる粒子のエネルギーに依存する。すなわち,同じ表面放出率であっても,エネルギースペクトルが異な
る二つの線源は,同じ放射線測定器に対して異なる計数率を与える。これは,固有効率Iiが一般的に入射
粒子のエネルギーに依存すること,及び単位時間に検出器に入射する粒子の数が空気の吸収の違いによっ
て変化するからである。したがって,厳密には,機器効率ε iも線源の構造に多少依存するものであり,単
位面積当たりの放射能を算出するときには,実際の放射性表面汚染からのエネルギー分布にふさわしい機
器効率であることが望ましい。単位時間に検出器に入射する粒子の数及びエネルギースペクトルは,校正
時と実際の汚染測定時との幾何学的条件のわずかな違いに非常に敏感であるという点も留意しなければな
らない。しかし,実際の放射線管理の目的からは,このようなスペクトルの違いによる影響は無視するこ
とができ,適切なエネルギーの標準線源による機器効率ε iの値をそのまま用いることができる(箇条5参
照)。
12
Z 4504:2008 (ISO 7503-1:1988)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
A.4 線源効率の推奨値
A.4.1 標準線源
標準線源の線源効率ε SCは,放射能及び表面放出率の両方で校正されていれば定まる値である(
A
q
εs
π
2
=
,
表A.1参照)。
注記 飽和層線源という特殊な線源の場合は,飽和層中の放射能だけに着目して校正されているとき
は,ε Sの定義式における放射能Aも飽和層の中の放射能だけを意味する。このことは箇条5に
おけるε iの評価に重要である。
標準線源(放射能面積:V cm2)が,放射能A又は単位面積当たりの放射能A*のいずれかだけで校正さ
れている場合には,ε SCの値は0.5とする。すなわち,箇条5の式(3)において,Esc=(0.5 A) /V,又はEsc=
0.5 A*ということになる。この考え方は,後方散乱による表面放出率の増加が極端に大きくなければ, ε i
に対して安全側の評価,すなわち,真値より低い機器効率を与えることになる。一般的に,放射能で校正
された市販の標準線源は,後方散乱の少ない物質(例えば,アルミニウム)にマウントされている。この
規格が対象としているすべてのβ線エネルギーについて,アルミニウムにマウントされた薄いβ線源の飽
和後方散乱は約30 %であり,プラスチック及び他の低原子物質では20 %より小さい。また,α線源の後
方散乱は,多くの場合5 %より少ない。
A.4.2 放射性表面汚染
実際の放射性表面汚染の線源効率ε Sは,評価が難しく,放射性表面汚染の構造上の相違によって,けた
の違った値になることもあり得る。後方散乱は計数率を増加させるので,後方散乱を無視することは,表
面汚染密度の算出に対して,高い数値を与えることになり安全側の評価となる。このため,この規格では
放射性表面汚染の中での自己吸収だけを考慮することとする。
β線放出核種に対するε Sの推奨値は,次に示すタイプの放射性表面汚染を想定して定めたものである。
− 厚さ約2.5 mg/cm2の非放射性物質による被覆がある薄い板状の放射性表面汚染
− β線放出核種が均一に分布した,厚さ10 mg/cm2程度のふき取りろ紙
一番目のタイプは直接測定の場合であり,二番目のタイプは間接測定法の場合である。いずれの場合に
おいても,放射性表面汚染内での吸収による線源効率の損失は,Eβmax≧0.4 MeVのβ線放出核種の場合は
無視できる(ε S=0.5)。0.15 MeV<Eβmax<0.4 MeVのβ線放出核種の場合は,平均すると約0.25の線源効
率となる。これらの線源効率の値を用いると,前述のタイプの放射性表面汚染よりも吸収の大きい非放射
性物質で覆われている場合には過小評価になる。しかし,このような放射性表面汚染からの放射性物質の
摂取,吸入又は外部放射線の寄与は比較的小さい。
α線放出核種の場合には,実際の放射性表面汚染の線源効率ε Sは,容易に0に近い値となるので,適切
で安全側となるような評価は,更に困難なものとなる1)。α線放出核種の飽和層厚線源の理論的な線源効
率ε S,αの値は,0.25であり,ほとんどのα線放出核種の飽和層厚さは,5 mg/cm2程度である。ε S,α=0.25
の値は,α線放出核種による重要な二つのタイプの放射性表面汚染,すなわち,直接測定法の場合のα線
放出核種が均一に分布した飽和層厚さ以下の線源層の汚染,及びふき取り試験の放射性物質が均一に分布
したふき取りろ紙などに適用できる。一方,ε S,α=0.25の値を用いることは,α線放出核種が飽和層より
も深い部分にある場合,又は線源層が薄くても飽和層厚さの50 %よりも厚い非放射性物質で覆われてい
る場合には,単位面積当たりの表面汚染密度を過小評価することになる。ε Sの推奨値を表A.2に示す。
注1) RAGHQVAYA, M., GIRIDAR, J. and MARKOSE, P.M. Correction for Self Absorption in Alpha
Sources, Health Physics, Pergamon
Press, 29, Nov. 1975: pp. 785-786.

13
Z 4504:2008 (ISO 7503-1:1988)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
表A.2−ε Sの推奨値
放射線粒子の種類・エネルギー
(MeV)
ε S
補足
β粒子(Eβmax≧0.4)
0.5
β粒子(0.15<Eβmax<0.4)
0.25
α粒子
0.25
次の場合は安全側の値となる。
− 飽和層厚さ以下の均一な汚染
− ふき取り試料

14
Z 4504:2008 (ISO 7503-1:1988)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
表A.3−この規格を適用するβ線放出核種の例
核種
半減期
max
β
E
keV
β
E
keV
βP
%
20
ME>
P
%
補足
14C
5 730年
154
49
100
−
C
18F(β+)
110分
634
250
96.7
−
24Na
15時間
1 390
554
100
−
C
28Mg
20.9 時間
860
152
100
29.6
*,eq
28Al
2.24分
2 864
1 242
100
−
32Si
330年
213
65
100
−
32P
14.3日
1 710
694
100
−
C
33P
25.4日
249
77
100
−
35S
87.4日
167
49
100
−
C
36Cl
3.01×105年
710
251
99
−
42K
12.4時間
3 521
1 430
100
−
C
43K
22.6時間
1 817
307
99.3
−
44Sc(β+)
3.93時間
1 476
633
94.4
−
45Ca
163日
257
77
100
−
C
46Sc
83.8日
357
112
100
−
C
47Ca
4.54日
1 988
345
100
−
C *,no eq
47Sc
3.42日
601
162
100
0.4
C
48Sc
43.7時間
657
220
100
0.2
56Mn
2.58時間
2 848
830
99.9
−
59Fe
44.6日
1 565
118
99.9
−
C
60Co
5.27年
318
96
100
−
C
65Ni
2.52時間
2 137
632
100
−
69mZn(IT)
13.8時間
−
−
5.1
§
69Zn
56分
905
321
100
−
72Ga
14.1時間
3 158
498
100
0.4
76As
26.3時間
2 969
1 064
100
−
77Ge
11.3時間
2 486
647
99.7
3.7
*,no eq
77As
38.8時間
690
229
100
−
82Br
35.3時間
444
137
99.3
−
82Sr(EC)
25日
−
−
−
−
§
82Rb(β+)
1.25分
3 356
1 474
95.5
−
86Rb
18.7日
1 774
667
100
−
C
89Sr
50.6日
1 491
583
100
−
C
90Sr
28.6年
546
196
100
−
C *,eq
90Y
64.1時間
2 260
935
100
−
91Y
58.5日
1 543
602
100
−
92Sr
2.71時間
1 930
199#
100
−
*,no eq
92Y
3.54時間
3 634
1 447
99.9
−
93Y
10.1時間
2 890
1 173
100
0.2
94Nb
2.03×104年
471
146
100
0.2
96Nb
23.4時間
749
249
100
0.5
97Zn
16.9時間
1 914
696
100
−
97Nb
72.1分
1 275
466#
100
0.2
98Tc
4.2×106年
394
118
100
0.4
99Tc
2.13×105年
294
85
100
−
106Ru
368日
39
10
100
−
C §
106Rh
30秒
3 540
1 411
100
−
110mAg
250日
530
67#
98.4
1.5
C
111Ag
7.46日
1 028
350
100
0.1
C

15
Z 4504:2008 (ISO 7503-1:1988)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
表A.3−この規格を適用するβ線放出核種の例(続き)
核種
半減期
max
β
E
keV
β
E
keV
βP
%
20
ME>
P
%
補足
113Cd
13.7年
586
185
100
−
115Cd
44.6日
1 621
606
100
−
C
117Cd
3.36時間
1 916
204#
99.2
1.3
*,eq
117In
43.8分
1 140
245
100
15.6
122Sb
2.7日
1 981
575
97.5
0.6
123Sn
129日
1 397
520
100
−
124Sb
60.2日
2 302
378#
100
0.4
C
126Sb
12.4日
1 790
289#
100
2.1
130I
12.4時間
1 176
279
99.5
1.9
131I
8.04日
807
182
99.9
6.7
C
132I
2.3時間
2 140
482
100
0.7
134Cs
2.06年
658
156
100
0.8
C
137Cs
30.2年
1 173
171#
100
−
C §
137mBa(IT)
2.6分
−
−
−
139Ba
83.1分
2 306
893
100
4.2
140La
40.2時間
2 164
527
100
2.1
C
142La
95.4分
4 517
848 #
100
0.3
142Pr
19.1時間
2 159
809
100
−
143Pr
13.6日
935
316
100
−
144Ce
284.3日
318
82
100
13.5
C *,eq
144Pr
17.28分
2 996
1 207
100
−
147Pm
2.62年
225
62
100
−
148Pm
5.37日
2 464
726
100
0.2
C
149Pm
53時間
1 071
364
100
0.2
159Gd
18.6時間
975
311
100
4.6
169Er
9.4日
350
99
100
−
175Yb
4.19日
468
126
100
5.27
185W
75.1日
432
126
99.9
−
C
186Re
90.6時間
1 077
349
93
14
C
188W
69.4日
349
99
100
0.3
*,eq
188Re
17時間
2 120
764
100
12.5
194Ir
19.2時間
2 251
808
100
1.1
198Au
2.7日
961
311
100
4.2
C
204Tl
3.78年
770
244
97.4
−
C
209Pb
3.25時間
644
198
100
−
注記 記号の意味は,次による。
β
E:β線平均エネルギー
Pβ:β壊変する確率。
PME>20:20 keV以上の単色エネルギー電子を放出する確率。
C:広く用いられている核種。
*:逐次壊変核種のうち,親核種も子孫核種も同程度の機器効率で測定できるもの。
§:逐次壊変核種のうち,一般的に,親核種又は子孫核種の一方だけ(下線を付した核種)を検出できるもの。
eq:一般的に放射平衡が成立するもの。
no eq:一般的には放射平衡が成立しないもの。
♯:E βmaxとE βとの関係が一般的でないもの。
(β+):陽電子放出核種
(EC):軌道電子捕獲核種
(IT):核異性体転移核種