2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
日本工業規格 JIS
K 0132-1997
走査電子顕微鏡試験方法通則
General rules for scanning electron microscopy
1. 適用範囲 この規格は,走査電子顕微鏡を用いて,主として二次電子による試料表面の微小部の形態
観察と分析を行う場合の一般的事項について規定する。
備考 この規格の引用規格を,次に示す。
JIS K 0050 化学分析方法通則
2. 共通事項 共通事項は,JIS K 0050による。
3. 用語の定義 この規格で用いる主な用語の定義は,次による。
なお,括弧内の対応英語は参考のために示す。
(1) 走査電子顕微鏡 (scanning electron microscope : SEM) 細く集束した電子プローブを試料上で二次
元的に走査することによって,試料から得られる二次電子等を用いて拡大像を形成することを基本機
能とする顕微鏡。
(2) 電子プローブ (electron probe) 電子銃部から放出された一次電子をレンズで直径数μmから10nm以
下に集束させ,試料に照射する電子線。
(3) 試料 (specimen) 観察又は分析の対象となる物質。
(4) エミッタ (emitter) 電子を放出する物質。
(5) 一次電子 (primary electron) エミッタから放出され,試料に照射される電子。
(6) 散乱電子 (scattered electron) 電子プローブの試料への照射によって,前方,又は後方に散乱される
電子。
(7) X線 (X-rays) 電子プローブの試料への照射によって,その試料から放出されるX線領域(0.01〜
100nm程度)の波長をもつ電磁波。
(8) 電子銃 (electron gun) 電子線を発生させるもの。
(9) レンズ (lens) 電子線の径を縮小(又は拡大)するためのもの。磁界を用いたレンズと電界を用いた
レンズがある。
(10) 二次電子 (secondary electron) 電子プローブの試料への照射によって,試料から放出される電子の
うち運動エネルギーの低い電子。通常数10eV以下の運動エネルギーをもつ。
(11) 検出器 (detector) 電子プローブを試料に照射することによって発生する信号を捕そくするもの。
(12) アノード (anode) エミッタからの放出電子を加速,又はエミッタから電子を引き出すため,エミッ
タに対向して設置される電極。
(13) 反射電子 (backscattered electron) 散乱電子のうち,後方に散乱されて試料から放出される運動エネ
ルギーの高い電子。電子プローブの電子と同程度の運動エネルギーをもつ。
2
K 0132-1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
(14) カソードルミネッセンス (cathodoluminescence) 電子プローブの試料への照射によって,試料から
放出される紫外,可視,赤外領域の波長をもつ電磁波。
(15) 吸収電子 (absorbed electron) 散乱電子のうち,試料中でエネルギー損失し吸収される電子。
(16) 透過電子 (transmitted electron) 散乱電子のうち,試料を透過して放出される電子。
(17) 弾性散乱 (elastic scattering) 電子が試料の構成原子と衝突して散乱する際に電子及び原子のもつ全
運動エネルギーが衝突前後で変化しない散乱。
(18) 非弾性散乱 (inelastic scattering) 電子が試料の構成原子と衝突して散乱する際に電子及び原子のも
つ全運動エネルギーが衝突前後で変化する散乱。
(19) 加速電圧 (accelerating voltage) 試料に照射される電子の運動エネルギーの電圧換算値。
(20) 試料傾斜角 (specimen tilting angle) 試料表面の法線と電子プローブとのなす角度。
(21) 二次電子放出率 (secondary electron yield) 一次電子を試料に照射することによって放出される二次
電子の割合を,一次電子1個当たりの二次電子の数で表したもの。
(22) 特性X線 (characteristic X-rays) X線のうち,試料中の元素に固有の波長をもつX線。
(23) 波長分散形X線分析 (wavelength dispersive X-ray spectroscopy) 試料から発生するX線を分光結晶
を備えた波長分光器を用いて分光する方式。
(24) エネルギー分散形X線分析 (energy dispersive X-ray spectroscopy) 試料から発生するX線をX線エ
ネルギーに比例した電気信号を発生する検出器を用いてエネルギー選別して分光する方式。
(25) プローブ電流 (probe current) 電子プローブの電流。
(26) 倍率 (magnification) 得られる像の実寸に対する拡大率。
(27) 対物レンズ絞り (objective aperture) 対物レンズを通過する電子プローブの開き角を制御する絞り。
(28) エミッション電流 (emission current) エミッタから放出される電子線による電流。
(29) 試料調製 (specimen preparation) 試料を顕微鏡で観察・分析するための前処理。
(30) 表面コーティング (coating) 試料表面を導電性物質で被覆する処理。
(31) 割断 (fracturing) 試料の内部構造を保って試料を割る処理。
(32) 固定 (fixation) 試料の形態・構造を化学的・物理的に保持する処理。
(33) 脱水 (dehydration) 試料中の水を他の液体で置換する処理。
(34) 非点収差補正 (astigmatism correction) 通常真円にはなっていない電子プローブを補正レンズを用
いて真円に近づける操作。
(35) チャージアップ (charging effect) 主に一次電子によって引き起こされる帯電現象。
(36) ワーキングディスタンス (working distance) 対物レンズの磁極端面と試料表面との距離。作動距離
ともいう。
(37) 走査時間 (scanning time) 試料上を電子プローブで走査する一周期の時間。
4. 装置
4.1
装置の構成 走査電子顕微鏡は,電子銃部,レンズ部,偏向走査部,試料室・試料ステージ部,検
出器部,真空排気部,電源・制御部,信号処理・像表示部から構成される。図1に装置の基本構成を示す。
(1) 電子銃部 電子を発生させる系。エミッタ,アノード,電子銃の軸合わせ機構などから構成される。
通常,電子は50 kV以下で加速される。電子銃には熱電子放出形,電界放出形がある。
(2) レンズ部 電子プローブの径を縮小するための系。通常,2段以上の磁界又は電界レンズが用いられ,
試料に対面するレンズを対物レンズ,それ以外のレンズを集束レンズ(又はコンデンサーレンズ)と

3
K 0132-1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
呼ぶ。
(3) 偏向走査部 電子プローブを偏向し,試料上で走査するための系。
(4) 試料室・試料ステージ部 試料を微動する試料ステージと,試料ステージを組み込む試料室から構成
される系。試料ステージには形態観察・分析のための試料が装てんされ,通常,試料は接地電位に保
持される。大口径の半導体ウェハを観察するための専用の大形試料ステージと大形試料室をもった装
置や試料室の真空度を中・低真空(1〜2 700Pa程度)に調整可能な装置など,特化した装置もある。
試料室には二次電子検出器のほか,反射電子検出器,X線検出器,カソードルミネッセンス検出器な
どの附属装置を取り付けられる装置もある。
図1 走査電子顕微鏡の構成の一例
(5) 検出器部 電子プローブを試料に照射することによって発生する二次電子や反射電子などの信号を捕
そくする系。
(6) 真空排気部 主に電子銃部,レンズ部,試料室部を真空排気する系。電子銃部などを超高真空排気に
対応させた装置もある。
(7) 電源・制御部 高電圧電源・制御部,レンズ電源・制御部,走査電源・制御部に大別される。
(a) 高電圧電源・制御部 電子銃,二次電子検出器,像表示用陰極線管 (CRT) に高電圧を印加し,制
御する系。
(b) レンズ電源・制御部 レンズに電流又は電圧を印加し,制御する系。
(c) 走査電源・制御部 偏向走査部に偏向・走査信号を印加し,制御する系。
(8) 信号処理・像表示部 検出器部からの電気信号を増幅・信号処理し出力する回路部,及びその信号を
CRT等に画像表示する像表示部と記録部から構成される系。二次電子像,反射電子像やX線像を選択
し,表示する機能や画像記憶機能をもつものもある。
4.2
装置の設置条件 装置の設置に当たっては,設置空間,電源・接地,給排水(水温,水圧,流量な
ど),高圧ガス(種類,圧力,流量など),温度・湿度,じんあい(塵埃),有害・腐食性物質,直射日光,
床強度,床振動,浮遊磁場(直流,交流),騒音などについて考慮すること。
5. 形態観察・分析法の原理 試料面上を電子プローブで二次元的に走査し,試料と電子線の相互作用に
よって発生する二次電子や反射電子を検出して拡大像を形成し,試料の形態観察を行う。通常,この観察
結果をもとに試料面上の分析位置を決定する。すなわち,電子プローブを照射する試料面上の二次元位置
に対応して発生する二次電子,反射電子,X線,カソードルミネッセンス,吸収電子,透過電子などを検
出・分光することによって試料の形態観察,寸法測定,元素分析,欠陥解析などを行う。
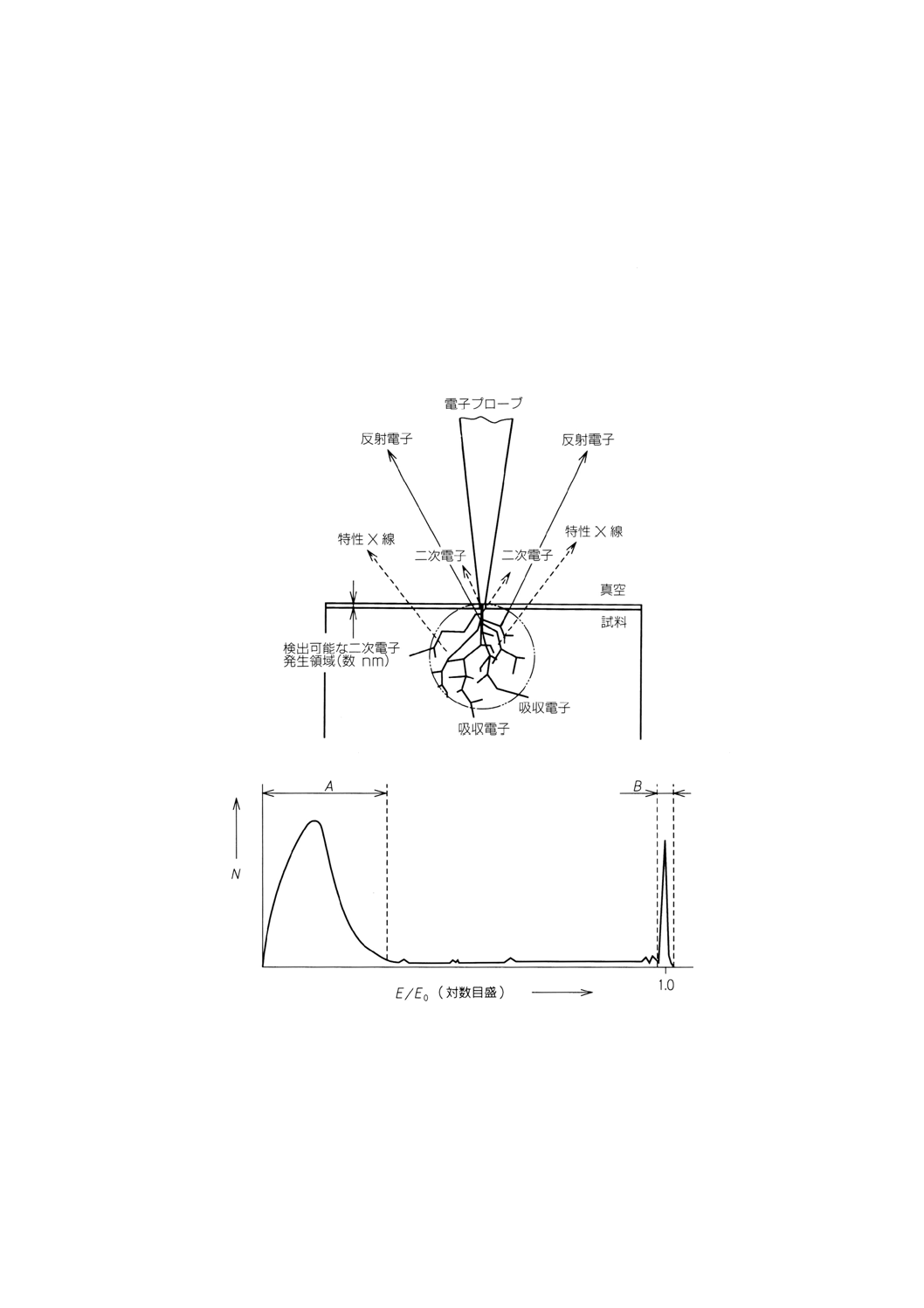
4
K 0132-1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
5.1
電子線との相互作用と発生する信号 試料に入射した一次電子は試料を構成する原子との相互作用
によって,弾性散乱や非弾性散乱される。この相互作用を経て,二次電子,反射電子などの電子やX線,
カソードルミネッセンスなどの電磁波が試料表面から放出される。これらの信号は,試料の固有の情報と
して利用できる。電子プローブを試料に照射したとき試料から発生する信号とその発生領域の関係を図2
に示す。試料に一次電子を入射したとき試料から放出される電子のエネルギー分布を図3に示す。縦軸に
発生した電子数 (N),横軸に発生した電子のエネルギー (E) と一次電子のエネルギー (E0) の比を示して
いる。領域Aの数十eVまでの低いエネルギー領域の電子を二次電子,領域Bの入射電子のエネルギーに
近いエネルギーをもつ電子を反射電子と呼ぶ。主な信号の性質と発生過程は次のとおりである。また,吸
収電流や薄膜試料における透過電子を信号として利用することができる。
図2 電子プローブと固体試料の相互作用による検出信号と発生領域の模式図
図3 入射一次電子のエネルギー (EO) に対する試料から放出される電子のエネルギー分布
(1) 二次電子 試料内に入射した一次電子が試料を構成する原子との相互作用によりエネルギーを失う過
程で二次電子が発生する。このうち,試料表面から数nm以内の領域で発生した二次電子だけが試料
外へ放出される。二次電子の発生量は,電子プローブの加速電圧・電流,電子プローブ照射位置の凹
凸構造,組成・密度・仕事関数,試料傾斜角,などに依存する。二次電子像のコントラストは,主と
して試料の凹凸構造・組成・密度が反映される。そのため,二次電子像は主として試料表面の形態観
察,寸法測定などに用いられる。半導体素子の表面電位・磁性材料の磁区観察などに用いられる場合
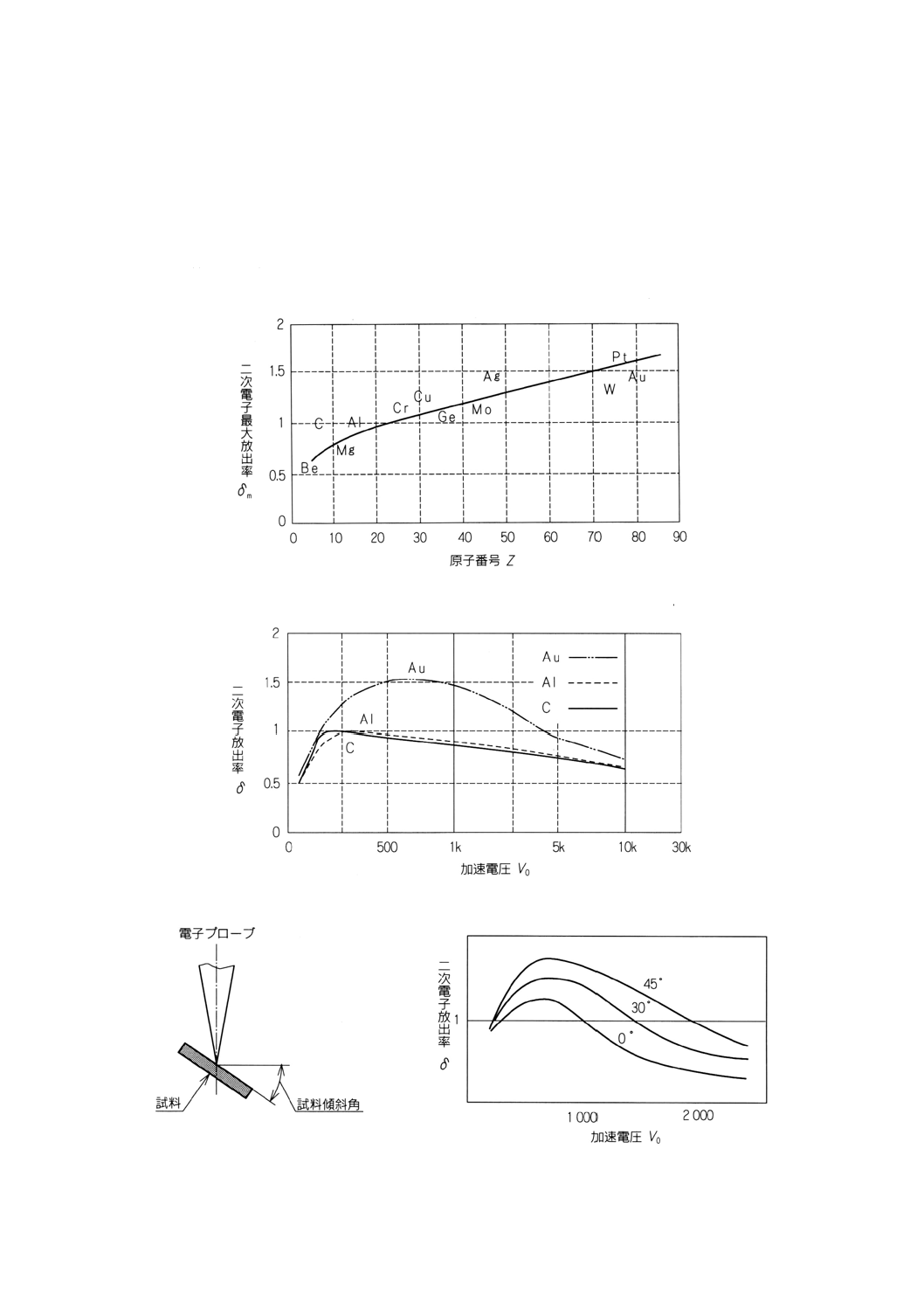
5
K 0132-1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
もある。
電子プローブを平たんで清浄な試料表面に垂直に照射した場合の,原子番号Zに対する二次電子放
出率δの最大値δmを図4に示す。Au, Al, Cにおけるδの電子プローブの加速電圧V0 (V) に対する依存
性を図5に示す。
また,試料傾斜角とVOに対するδの依存性を図6に示す。二次電子の検出には,シンチレータと光
電子増倍管を組み合わせた二次電子検出器が一般的に用いられる。
図4 原子番号Zに対する二次電子放出率の最大値δm(1)
注(1) δmに対応する加速電圧は元素によって異なる。
図5 電子プローブの加速電圧VOに対する二次電子放出率δ
図6 試料傾斜角0°(水平),30°,45°における二次電子放出率δの変化

6
K 0132-1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
(2) 反射電子 試料内に入射した一次電子が試料を構成する原子によって後方に散乱され試料から再放出
されて反射電子となる。その発生領域とエネルギーは電子プローブの加速電圧に依存する。反射電子
の発生量は,電子プローブの加速電圧・電流,試料傾斜角,電子プローブ照射位置の凹凸構造,構成
元素の原子番号・密度などに依存する。反射電子像のコントラストは,主として試料の構成元素の原
子番号と凹凸構造が反映される。そのため,反射電子像は,主として,試料の組成や形態の観察など
に用いられる。結晶性試料の結晶粒の方位解析や,磁性材料の磁区観察などに用いられる場合もある。
電子プローブを試料表面に垂直に照射した場合の,原子番号Zに対する反射電子の放出率を図7に
示す。反射電子の検出には,半導体検出器,シンチレータ形検出器などが用いられる。
図7 原子番号Zに対する反射電子の放出率
(3) X線 試料内に入射した一次電子が試料を構成する原子の内核電子を励起させた場合,その緩和過程
で励起状態と基底状態のエネルギー差に相当する特性X線が放出される。特性X線は元素分析に用い
られる。構成元素の化学結合状態の識別に用いられる場合もある。特性X線の発生領域は,電子プロ
ーブの照射位置の周辺の数μm以内である。特性X線の発生量は,電子プローブの加速電圧・電流,
試料傾斜角,電子プローブ照射位置の組成・密度などに依存する。特性X線の検出には,エネルギー
分散形又は波長分散形の検出器が用いられる。
(4) カソードルミネッセンス 試料内に入射した一次電子が試料を構成する原子の外核電子を励起し,基
底状態へ遷移したときに,励起状態と基底状態のエネルギー差に相当する,物質に固有の紫外,可視,
赤外領域の電磁波が放出される場合がある。カソードルミネッセンスは構成原子の化学結合状態の局
所的な違いの検出などに用いられる。カソードルミネッセンスの発生領域は,電子プローブの照射位
置の周辺の数μm以内である。カソードルミネッセンスの発生量は,電子プローブの加速電圧・電流,
電子プローブ照射位置の結晶構造,不純物,結晶欠陥などに依存する。カソードルミネッセンスの検
出には分光器などが用いられる。
5.2
分解能 電子線をプローブとした走査電子顕微鏡の観察像の分解能は,(1)電子プローブの直径(電
子プローブ径),(2)電子プローブ径に対する検出信号発生領域,(3)プローブ電流と信号検出器から観察像
形成,又は分析までの系の信号と雑音の比 (S/N) に依存する。
また,外部じょう乱などの装置設置環境によって分解能が低下する場合がある。
7
K 0132-1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
(1) 電子プローブ径d0 装置の性能に依存する電子プローブの直径d0は,電子源の大きさと全レンズ系に
よる倍率で決まる電子源の縮小径と電子の放出エネルギーのばらつき,レンズの収差によるボケから
Smith(2)の式で近似的に予測することができる。
2
/1
2
2
2
2
2
0
)
(
a
c
s
f
m
d
d
d
d
d
d
+
+
+
+
=
,
電子源の縮小径
: dm=Mv・dg
回折収差によるボケ : df=0.61λ/α
球面収差によるボケ : ds= (Cs/4) ・α3
色収差によるボケ
: dc= (Cc・⊿E/E0)・α
非点収差によるボケ : da=Ca・α
ここで,Mvは全レンズ系の縮小倍率。dgは電子源直径。αは対物レンズ絞りによって規制される電
子プローブの試料入射ビーム半角 (rad),E0は一次電子線の加速エネルギー(eV:エレクトロンボル
ト),λはE0の電子線の波長 (m),⊿Eはエミッタから放出される電子のエネルギー幅 (eV),Csは対
物レンズの球面収差係数 (m),Ccは対物レンズの色収差係数 (m),Caは対物レンズの非点収差係数 (m)。
市販装置の最小電子プローブ径は,加速電圧25 kVの熱電子放出形電子銃でほぼ10 nm以下,電界
放出形電子銃でほぼ2 nm以下が得られる。
注(2) K. C. A. Smith, Ph. D. Dissertation, Cambridge University (1956)
(2) 電子プローブ径に対する検出信号の発生領域 二次電子像の分解能は,図2に示したように試料の表
面層から放出された二次電子を検出するため,主たる発生領域は電子プローブ径に依存する。一方,
反射電子,X線やカソードルミネッセンス像は,試料に入射した一次電子の試料内での散乱によって,
電子プローブ径に比べて信号発生領域が広がるため,それらの分解能は信号発生領域に依存する。
(3) プローブ電流ipと信号検出 試料に照射する電子プローブのプローブ電流ipは次の式で与えられる。
ip=0.25π2・β・ (d0) 2・α2
ここで,βは電子源の輝度 (A・m-2・sr-1)
プローブ電流は,集束レンズの励起条件,対物レンズ絞り孔径の可変,電子銃のエミッション電流
などによって変化する。プローブ電流の増加は,エミッション電流の増加,集束レンズの弱励起,対
物絞り孔径の増加で得られる。
二次電子,反射電子,X線やカソードルミネッセンスなどの検出信号はプローブ電流量に比例する
が,各信号の発生率や試料に依存する発生率,検出器の検出効率などから測定可能範囲が制限される。
図8は各信号検出に適したプローブ電流の範囲を示す。
観察像の分解能を向上させるために,電子プローブ直径を細くし,プローブ電流が減少した場合,
観察像を得るのに必要とする信号のS/Nが得られず,分解能が制限されることがある。人間の目で識
別できる限界は,経験的にS/Nが5以上とされている。図9に雑音ノイズを含む信号とコントラスト
を示す。画像の信号は (Sa+B) で,Saを画像のコントラスト,Bを画像のブライトネスと呼ぶ。信号
のS/Nは,S=
a
S+B, N=
2/1)
(
B
Sa+
と定義される。ここで,a
Sは画像コントラストSaの平均値で示
される実効信号幅である。
S/Nが5以下で得た二次電子像では,電子プローブ直径と同程度以下の試料の微細構造の観察は電
子プローブ径で決まる分解能が画像信号のS/Nから制限されることがある。

8
K 0132-1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図8 各信号検出に対するプローブ電流の使用範囲の例
図9 雑音信号を含む信号とコントラスト
(4) 像分解能
(a) 二次電子像の分解能 二次電子信号として大きなコントラストが得られ,そして分解能値に見合っ
た微細構造をもった試料を用いる。例えば,カーボン基板や磁気テープなどに金や白金などを薄く
蒸着した試料がある。この試料で得られた二次電子像の蒸着粒子の直交する異なった二方向の最小
粒子間隔を測定し,これをSEMの分解能と定義することが一般的である。
(b) 反射電子像の分解能 二次電子像の分解能確認試料と同様のものを用いている。
5.3
観察像の倍率及び校正 観察像の倍率は,電子プローブが試料上を二次元走査した寸法とCRTなど
の画像拡大表示の寸法の比である。これを図10に示す。試料を傾斜しない場合においてのみ,X軸とY
軸方向の倍率が同一となる。多くの走査電子顕微鏡は,CRTなどの拡大された画像にその倍率を示すため
に,試料傾斜によって倍率が変わらない軸方向の倍率やスケールバーなどを表示する機能を備えている。
電子プローブの偏向走査寸法とCRTなどの画像表示の寸法と直線性の確認のために倍率校正が行われる。
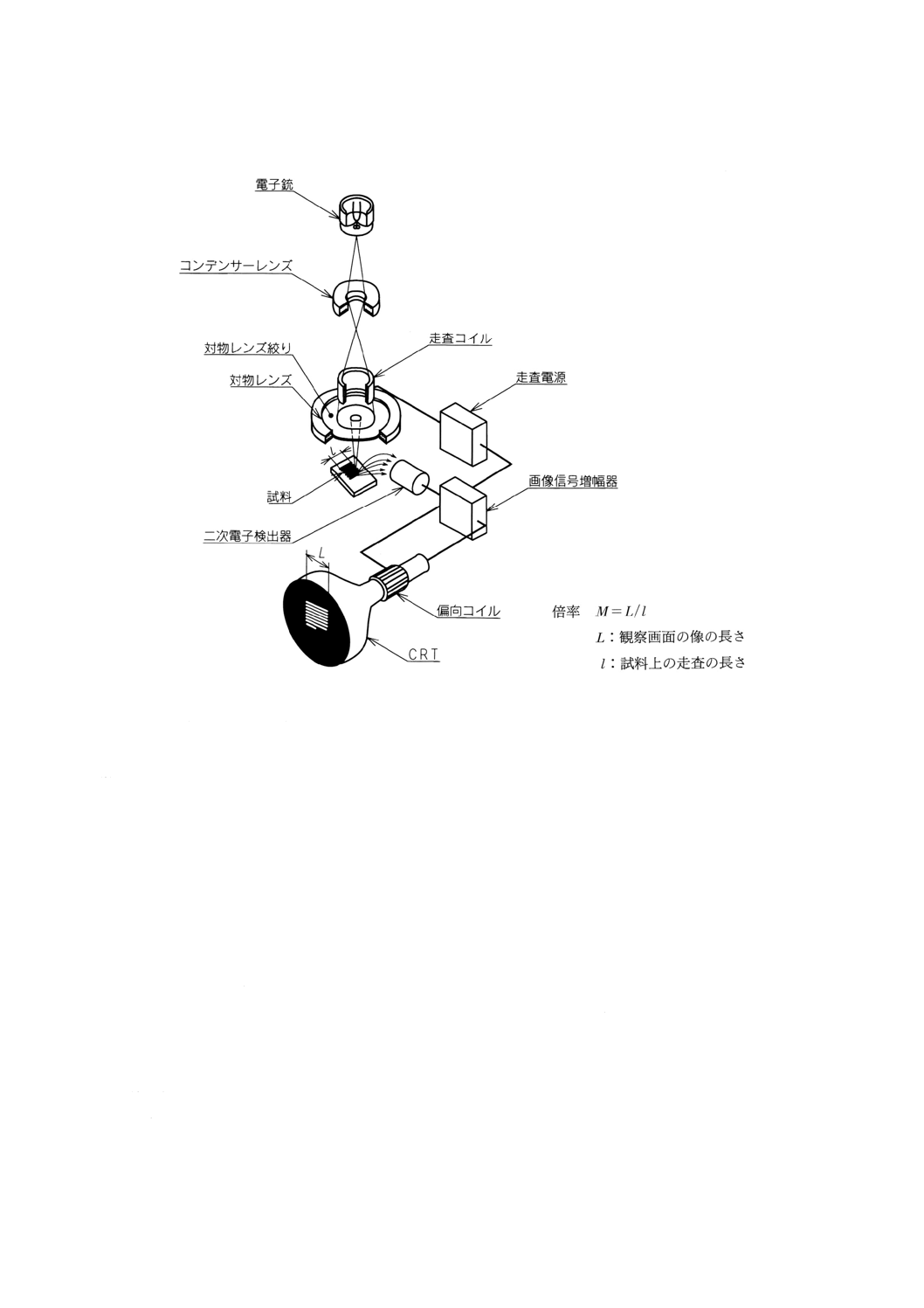
9
K 0132-1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図10 走査電子顕微鏡の倍率
(1) 倍率校正用試料 倍率を校正するための試料としては,市販の寸法校正されたAu, Cu, Ni製の100メ
ッシュ(ピッチ254μm),1 000メッシュ(ピッチ25.4μm),や高分子製の1.09μm径及び0.230μm径
のラテックス,0.240μmのSiのマイクロスケールなどが用いられている。
(2) 倍率精度 一般的に,市販装置(小形・廉価装置を除く)における記録された像の倍率及びスケール
バー表示の精度は,試料の帯電,外部じょう乱などがない場合は,装置の表示倍率の範囲において±
10%以下の精度が保証されている。
5.4
X線分析 走査電子顕微鏡の試料室に特性X線の検出器を装着すると,試料の局所的な組成を分析
することができる。検出器にはエネルギー分散形と波長分散形がある。両検出器の元素分析範囲,分析検
出限界,定量分析精度などの比較を表1に示す。
エネルギー分散形は波長分散形に比べて測定時間が短く,多元素の同時測定に優れていることから走査
電子顕微鏡に多用されている。複数の波長分散形検出器を備えたX線分析を中心に行う専用装置は電子線
マイクロアナライザ(3)と呼ばれる。X線分析には定性分析と定量分析があり,それぞれ,二次電子像や反
射電子像によって形態・組成像の観察を行い,電子プローブによる点,線,面の分析モードを指定するこ
とによって,試料表面上の測定部位の分析を行う。
また,分析の際には,注目する元素からの特性X線の発生効率,特性X線の発生領域の大きさ,試料の
電子線照射によるダメージ,などを考慮して電子プローブの加速電圧・電流などの分析条件を設定する。
注(3) X線マイクロアナライザとも呼ばれていたが,走査電子顕微鏡,透過電子顕微鏡と同様に労働
安全衛生法施行令別表第2項第1号のX線装置に該当しないとの立場から電子線マイクロアナラ

10
K 0132-1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
イザに統一して呼ばれている。
表1 エネルギー分散形と波長分散形のX線分析の主な機能比較
エネルギー分散形
波長分散形
元素分析範囲
5B〜92U
4Be〜92U
検出方法
Si (Li) 半導体検出器によって
エネルギー分散する方式
分光結晶によって波長分散し,
比例計数管で検出する方式
分解能
エネルギー分解能(4)
E=138〜155 eV
(λ=約5×10-3 nm)
波長分解能
λ=約7×10-4 nm
(E=約20eV)
分析検出限界
1 500〜2 000ppm
50〜100ppm
定量分析精度
2〜3% (11Na〜92U)
1%以下 (4Be〜92U)
X線像の分解能
数μm
注(4) Mn試料から得られたMnKαのスペクトル又は放射線同位元素55Feのスペ
クトルの半値幅で定義された場合の値である。
5.5
観察像・測定データの記録
(1) 写真撮影法 二次電子像,反射電子像,X線像などの記録は,観察用CRT像を直接写真撮影する方式
と撮影用CRT像を写真撮影する方式がある。撮影用CRTには,走査線本数が1 000本/画面のものか
ら2 000本/画面以上のものまである。撮影用CRTの画像とスケールバーの寸法表示は,倍率に連動
して校正されている。写真撮影にはロールフィルムやインスタントフィルムなどが選択できる。
(2) 電子式記録法 画像記憶機能が組み込まれた走査電子顕微鏡では暫定的に記憶された画像を,電子式
のビデオプリンタ,又は外部接続された画像記憶装置に転送して,記録することができる。
X線分析などの測定機器に構成されているコンピュータに収集した測定データは各種方式のプリン
タで記録することができる。
6. 試料及びその調製方法
6.1
試料 観察・分析用の試料は,一般的に導体,半導体及び絶縁体の固体が対象となるが,液体や水
分などを含む試料の観察・分析も可能である。
試料の観察・分析に際して,次の事項を行う。
(1) 試料は観察・分析条件に適するように試料調製を行う。
(2) 塊状,板状,粉状などの試料は試料ステージ又はステージに固定する試料ホルダーに導電性ペースト,
導電性両面テープなどによって固定し,電気的な導通をとる。
(3) 試料汚染の原因となる真空試料室内でのガス放出などを防止するためには,導電性ペーストに含まれ
る溶媒などを十分に乾燥させる。
6.2
試料調製 試料調製には,次の方法がある。
(1) 試料の導電性の確保,電子線損傷からの保護及び二次電子放出率の向上などのための表面コーティン
グ処理
(2) 試料の観察・分析したい部位を露出・顕在化などするための破断・割断,表面研磨処理
(3) 粉体試料の観察・分析に適した分散処理
(4) 生物試料,水や油などの液体を含んだ試料などの観察・分析時に生じる変形を防ぐための固定・脱水・
乾燥処理,凍結処理
11
K 0132-1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
7. 装置の操作と確認 装置の使用開始に先立って,試料の確認,装置の取扱手順の確認や一定の確認基
準を設けて装置の点検を行い,異常のないことを確認した後,暖機運転を行って装置の安定化を図る。
7.1
装置の操作 装置の操作に当たって,試料及び必要とする像観察に対応して,次に述べる装置の性
能を確保するための調整と確認を併せて行う。通常の調整は,二次電子像で行う。
(1) 電子銃部 電子線発生源のエミッション電流と試料の観察目的に合わせ加速電圧の設定を行う。電子
銃の軸合わせを行う。エミッション電流の変動がないことを確認する。
(2) 偏向走査部 装置の調整に適した倍率設定と走査速度の設定を行う。観察像の視野選択,使用条件の
選択などは,TVスキャンなどの速い走査速度を,焦点合わせ,非点補正や高倍率観察の観察は,ス
ロースキャンの走査速度を用いる。X線分析時には,電子プローブの位置を設定する。
(3) レンズ部 試料面上に焦点を合わせるように対物レンズの焦点合わせと共に,対物絞りなどの軸合わ
せを行う。高倍率の像観察では,対物レンズの焦点合わせと共に非点収差補正を行う。非点収差補正
が十分でない時,対物絞りの軸合わせ,対物絞りの汚れ,電子プローブの通路の汚れや試料のチャー
ジアップを確認する。
(4) 試料ステージ部 試料ステージの移動機構の調整によって観察したい試料位置決め(視野選択)を行
う。移動機構の動きが滑らかであることを確認する。
(5) 検出部・表示部 検出器及びCRTなどの表示系の制御電源を調整して,CRT上の観察画像のコント
ラスト,明るさなどを指示表示に従って最適化を図る。また,観察・分析の目的に合わせて検出信号
の切換えを行う。一定の試料で観察画像の輝度や明るさの変動がないことを確認する。
7.2
観察・分析条件 観察・分析に適した測定条件を確認するため,加速電圧,エミッション電流,対
物絞り径の選択,プローブ電流,試料傾斜角,ワーキングディスタンス,画像信号のコントラスト,明る
さやX線計測器の計測定数などを変えて観察・測定する。
7.3
観察・分析の留意事項
(1) 試料調製による試料情報の損失
(a) 試料調製によって,試料の微細構造の消失や試料の変形や材料の変質やひずみなどがないか。試料
の汚染がないか。
(b) 表面コーティングの種類や厚さが厚いために表面の微細構造が損なわれていないか,コーティング
処理中の熱,又はイオンなどによる試料表面の変形,材料の変質やひずみが起きていないか。又は
試料の汚染がないか。
試料調製方法や試料表面処理方法を変えた数種類の試料を観察・測定してその有無を確認する。
(2) 二次電子像
(a) 高い加速電圧の観察 試料表面の凹凸情報が損なわれ,試料の内部情報が強調される。
(b) 試料のチャージアップ 画像に不定期なノイズが現れ,試料の視野移動した後も不規則にノイズが
変化する場合,加速電圧を下げるか,又は試料を傾斜させるなどして,現象の変化から判断する。
(c) 試料の電子線損傷 画像観察中に試料が変形する場合,加速電圧を下げる,プローブ電流を下げる
などによって,損傷の有無を確認する。
(d) 試料汚染 画像観察中に画像が徐々に暗くなる,観察倍率を下げると黒いこん跡がある場合,加速
電圧を下げる,プローブ電流を下げるなどして,試料汚染の有無を確認する。
(3) 反射電子像
(a) 試料の組成像,凹凸像や結晶方位のコントラストが低い場合,加速電圧を高くする,プローブ電流
を増すなどを行う。
12
K 0132-1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
(b) (2)の(b),(c),(d)と同じ現象か確認する。
(4) X線
(a) 試料に存在する元素が検出できない場合,X線の励起電圧以上の加速電圧にする,プローブ電流を
増す,X線計測系のカウントレートを増すことが必要である。
(b) プローブ電流が少なく,X線検出器の分析感度に対して必要とする信号のS/Nが低いとき,計測系
のバックグランドノイズで試料に存在する元素のピークを見落とすことがある。
(c) 得られたX線の結果にX線検出器の分解能の制約から生じる試料に存在しないX線ピークの重畳
や近接元素のピークの重畳などの誤認に留意する。
(d) (2)の(b),(c),(d)と同じ現象か確認する。
(5) カソードルミネッセンス
(a) カソードルミネッセンス像のコントラストが低い場合,加速電圧を高くする,プローブ電流を増す
ことが必要である。
(b) (2)の(b),(c),(d)と同じ現象か確認する。
(6) 設置環境のじょう乱による像障害 装置を設置する場所の床振動,外部磁場変動,音響振動など,入
力電源の変動やノイズなどの外部じょう乱は装置本来の分解能を制約する場合がある。加速電圧,観
察倍率や試料ステージのワーキングディスタンスなどを変えてその影響を確認し,その影響の出ない
範囲で観察する。又は設置室調査を行い,その原因を除去,設置場所の変更や装置の対策を施す。
7.4
記録データの整理 測定結果には次の事項のうち必要な事項を記載する。
(1) 一般事項及び装置仕様
(a) 測定年月日及び測定者名
(b) 装置,使用附属装置の名称と製造業者,型式名
(2) 試料及び試料処理
(a) 試料名,試料履歴
(b) 試料調製の方法
(3) 測定条件
(a) 加速電圧
(b) 倍率
(c) 信号の種類(二次電子像,反射電子像,X線分析など)
(d) 試料ステージの条件(ワーキングディスタンス,試料傾斜角など)
(e) 対物レンズ絞りの孔径
(f) プローブ電流又は吸収電流
(g) 写真撮影及び記録時の走査時間
(h) 分析条件(信号系の設定,計測時間など)
8. 装置の点検と安全管理
8.1
設備・装置の安全点検 点検を必要とする事項は装置によって異なるが,下記の主な事項を定めら
れた時間間隔,手順で行い,点検の記録を残すことが望ましい。
(1) 設備の点検
(a) 電源入力配電盤のヒューズ,ブレーカ,接地などの切断などの異変の確認。
(b) 給排水配管の水漏れ,高圧ガスの圧力の異変などの確認。
13
K 0132-1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
(c) 空調が設定どおり正常に作動しているか,換気が適切に正常作動しているか,などの確認。
(2) 装置の点検
(a) 装置入力電源部のヒューズ,ブレーカ,接地などの切断などの異変の確認。
(b) 高圧ガス配管や油回転ポンプ配管の緩みやひび割れなどの異変の確認。
(c) 機械的稼働部をもつ油回転ポンプ,空気コンプレッサ,ターボ分子ポンプ,試料ステージの駆動モ
ータなどの異常音や異変の確認。
(d) 装置の表示に異常がないか,異常を示す警告表示が表示されていないかの確認。
8.2
安全管理 観察・分析,及び設備・装置の管理・点検に当たって,各種の動力,電気,高圧ガスな
どによる災害を防止するための教育訓練を行い,適切な安全対策を施す必要がある。安全の確保には労働
安全衛生法,労働安全法施行令,労働安全衛生規則,電離放射線障害予防規則,放射線同位元素等による
放射線障害の予防に関する法律,高圧ガス取締法及び一般高圧ガス保安規則,製造物責任法など,安全に
関する法令を熟知し,作業に反映させなければならない。
9. 試料取扱い上の安全確認 試料の取扱いに当たって,有毒性,放射性,感染性などに留意し,安全確
保のために各種の関連法規を熟知し,作業に反映させなければならない。
10. 個別規格で記載すべき事項 走査電子顕微鏡による分析方法を規定する個別規定には,少なくとも次
の事項を記載しなければならない。
(1) 測定試料名
(2) 測定条件
(3) 測定試料の調製方法
14
K 0132-1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
走査電子顕微鏡分析方法通則JIS新規原案作成委員会 構成表
氏名
所属
(委員長)
永 谷 隆
埼玉工業大学
○ 岡 林 哲 夫
工業技術院繊維化学規格課
池 谷 浩之輔
通商産業省計量行政室
◎ 岡 山 重 夫
工業技術院電子技術総合研究所
○ 中 前 幸 治
大阪大学
○ 豊 田 幸 司
工業技術院計量研究所
○ 京 谷 陸 征
工業技術院物質工学工業技術研究所
○ 杉 林 進 治
財団法人日本規格協会
因 幸一郎
財団法人日本規格協会
嶋 貫 孝
社団法人日本分析化学会
○ 野 呂 寿 人
日本鋼管株式会社
○ 市 倉 栄 治
社団法人日本セラミックス協会(旭硝子株式会社)
○ 三 好 元 介
株式会社東芝
○ 木 村 利 昭
雪印乳業株式会社
○ 池 田 幸 介
日本電信電話株式会社
○ 大 浦 俊 彦
株式会社堀場製作所
○ 村 山 芳 昭
株式会社エリオニクス
○ 丹 羽 直 昌
株式会社島津製作所
○ 島 倉 昌 二
株式会社トプコン
○ 古 賀 康 憲
株式会社ニコン
○ 中 川 清 一
日本電子株式会社
○ 神 田 公 生
株式会社日立製作所
○ 久 本 泰 秀
社団法人日本分析機器工業会(株式会社日立製作所)
○ 池 田 久 幸
社団法人日本分析機器工業会(横河アナリティカルシ
ステムズ株式会社)
○ 宮 川 清 孝
社団法人日本分析機器工業会
備考 ◎印は,小委員会委員長,○印は,小委員会委員を兼ねる。