H 0609 : 1999
(1)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
まえがき
この規格は,工業標準化法に基づいて,日本工業標準調査会の審議を経て,通商産業大臣が改正した日
本工業規格である。これによって,JIS H 0609 : 1994は改正され,この規格に置き換えられる。
この規格の一部が,技術的性質をもつ特許権,出願公開後の特許出願,実用新案権,又は出願公開後の
実用新案登録出願に抵触する可能性があることに注意を喚起する。通商産業大臣及び日本工業標準調査会
は,このような技術的性質をもつ特許権,出願公開後の特許出願,実用新案権,又は出願公開後の実用新
案登録出願にかかわる確認について,責任をもたない。
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
日本工業規格 JIS
H 0609 : 1999
選択エッチング法による
シリコンの結晶欠陥の試験方法
Test methods of crystalline defects in silicon
by preferential etch techniques
序文 この規格は,半導体集積回路 (LSI) は半導体用シリコン単結晶内の結晶欠陥がその性能及び歩留ま
りに大きく影響するために,規定されてきた。この結晶欠陥を検出するためのエッチング液として従来は
クロムを含む液が大量に使用されてきたが,1994年の改正において環境管理面からクロムを含まないエッ
チング液に全面転換した。しかし,このエッチング液は低抵抗単結晶には適用困難であったが,今後の半
導体集積回路には低抵抗単結晶を使うエピ基板が大量に使われることになるため,今回の改正は低抵抗単
結晶でのクロムを含まないエッチング液を追加して規定したものである。
1. 適用範囲 この規格は,シリコンウェーハの結晶欠陥を六価クロムを含まない選択エッチング液によ
って検出し測定する方法について規定する。対象は,単結晶ウェーハ,エピタキシャルウェーハ及びこれ
らの熱酸化ウェーハで,これらの結晶面方位は, {100} 面, {111} 面及び {511} 面の3種類とする。
備考 ウェーハの種類は,次による。
a) 単結晶ウェーハ 単結晶のスライス,ラップ及び鏡面ウェーハ。
b) エピタキシャルウェーハ エピタキシャル成長したウェーハ。
c) 熱酸化ウェーハ a)の鏡面ウェーハ及びb)のウェーハを高温酸化したウェーハ。
上記の各ウェーハは抵抗率によって適用する選択エッチング液が異なり,0.02Ω・cmを超える高抵
抗率のウェーハには4.3b)の選択エッチング液(I)を,0.02Ω・cm以下の低抵抗率のウェーハには4.3c)
の選択エッチング液(II)をそれぞれ適用する。
2. 引用規格 次に掲げる規格は,この規格に引用されることによって,この規格の規定の一部を構成す
る。これらの引用規格のうちで,発行年を付記してあるものは,記載の年の版だけがこの規格の規定を構
成するものであって,その後の改正版・追補には適用しない。発行年を付記していない引用規格は,その
最新版を適用する。
JIS K 8355 : 1994 酢酸(試薬)
備考 ISO 6353-2 : 1983, R1相当
JIS K 8541 : 1994 硝酸(試薬)
備考 ISO 6353-2 : 1983, R19相当
JIS K 8550:1994 硝酸銀(試薬)
備考 ISO 6353-2 : 1983, R28相当
2
H 0609 : 1999
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
JIS K 8819 : 1996 ふっ化水素酸(試薬)
備考 ISO 6353-3 : 1987, R67相当
JIS K 8913 : 1996 よう化カリウム(試薬)
備考 ISO 6353-2 : 1983, R25相当
3. 用語の定義 この規格で用いる用語の定義は,次による。
参考に括弧内にASTM F 1241 : -95 Standard Terminology of Silicon Technologyと対応する英訳用語を示し,
内容の整合を図った。
a) 転位 (dislocation) 格子欠陥の一種。結晶の滑りを起こした領域とすべらない部分の境界線を転位線
と呼ぶ。転位線は,結晶内で閉じているか,又は結晶表面に達している。ウェーハ表面に達している
転位線は,選択エッチングによってエッチピットとして観察できる(写真1参照)。またスリップに起
因する転位をスリップ転位と呼ぶ(写真14,21,26参照)。
b) リネージ (lineage) 転位の配列から生じる小傾角粒界。この角度は,結晶の一部ともう一つの他の
部分との方位差であり,1分以下の範囲で変動する。選択エッチングでは,転位の配列は線状に並ん
だピットとして観察できる(写真2参照)。
c) スリップ (slip) 結晶の一部がその結晶形を保った形で,結晶の他の部分と相対的なせん断変位を起
こす塑性変形の過程。せん断変位は,特定の結晶面で特定の方位方向に起こる。シリコンでは {111} 面
で {110} 方向に滑りが起こる。選択エッチングでは,平行に並んだ直線状の転位ピットの列として観
察できる。表面が {111} 面の場合は,これらのピット列は他の列と60°で交差し {100} では90°で
交差している(写真3及び写真4参照)。
d) 成長じま (striation) 選択エッチングすると目視で渦巻状の模様として見られるしま。100倍程度に
拡大して見ると連続的な,しま模様である。抵抗率の局部的変動を伴って現れ,回転する固液界面に
生じる周期的結晶化現象によるものとされている。また,これはドーパント濃度,格子間酸素又は意
図せずに混入された不純物濃度の周期的変動を反映している(写真4参照)。
e) スワール (swirl) 選択エッチングすると目視で見られる渦巻状,又は同心円状の模様。100倍程度
の倍率で見るとピットの不連続な並びである(写真5参照)。
f)
積層欠陥 (stacking fault : SF) 結晶格子面の原子の積み重ね順序がくい違っている面状欠陥。ウェー
ハ内の既存のものと,酸化によって発生する酸化誘起積層欠陥 (oxidation induced stacking fault : OSF)
がある。欠陥面は, {111} 面に平行に挿入されるために,選択エッチングすると方向性をもった棒状
の溝として見られる。{111} ウェーハでは3方向に,{100} ウェーハでは直交した方向に配列してい
る(写真6,11,13,15,17,19,22,24参照)。
エピタキシャル層の場合は,基板表面の汚染や構造的欠陥によってエピタキシャル層の成長ととも
に積層欠陥も成長し,{111} 面上では選択エッチングによって1個,2個又は3個の側面をもつ正三
角形のように見える。{100} では正方形,又は直角の二辺若しくは一辺だけが見られる(写真7参照)。
g) シャローピット (shallow pits) 選択エッチングした表面で倍率200倍以上の顕微鏡で見られる小さ
な底の浅いピット。表面の金属不純物汚染などが原因である(写真8参照)。
h) 析出物 (precipitates) シリコンの格子の中に入り込んでいるシリコン酸化物領域。選択エッチング
すると倍率100倍以上の顕微鏡では,エッチピットとして見られる(写真9参照)。
i)
内部微小欠陥 (bulk micro defect : BMD) ウェーハ内部の転位や積層欠陥,析出物などの微小欠陥。
ウェーハを通常 {110} 面でへき開し選択エッチングしたときに,へき開面上に倍率100倍以上の顕微

3
H 0609 : 1999
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
鏡によって見られる微小欠陥(写真10参照)。
j)
無欠陥層 (denuded zone : DZ) 熱処理によってシリコン中の格子間酸素を外方拡散させ,表面近傍
に低酸素濃度層を作り析出などの発生が押さえられた層(写真10参照)。
写真1 エッチピット(スリップ誘起)
写真2 リネージとエッチピット FZ結晶 D液 10min.
写真3 スリップ

4
H 0609 : 1999
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
写真4 成長じまとスリップ誘起積層欠陥とピット
写真5 スワール {100} ,左半分A液4min,右半分ライト液4min.

5
H 0609 : 1999
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
写真6 酸化誘起積層欠陥 (OSF)
写真7 エピタキシャル層の積層欠陥
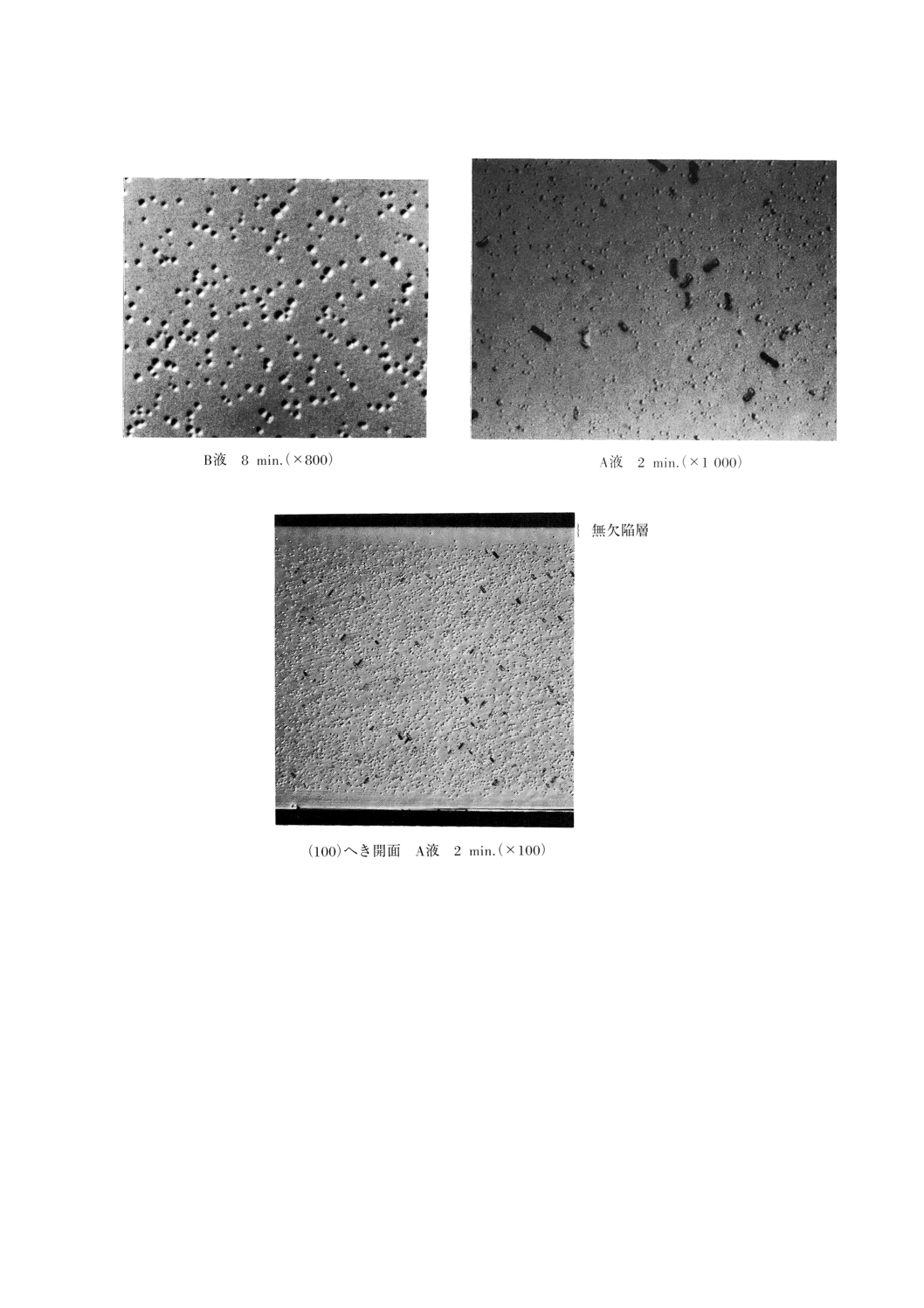
6
H 0609 : 1999
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
写真8 シャローピット
写真9 析出物と積層欠陥
写真10 内部微少欠陥と無欠陥層

7
H 0609 : 1999
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
写真11 OSF B {100} 表面
写真12 BMD B {100} へき開面
写真13 OSF,B {100} 表面
写真14 スリップ転位,B {100} へき開面
写真15 OSF B {100} 表面
写真16 BMD,B {100} へき開面

8
H 0609 : 1999
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
写真17 OSF,Sb {100} 表面
写真18 BMD,Sb {100} へき開面
写真19 OSF,Sb {111} 表面
写真20 BMD,Sb {111} へき開面
写真21 スリップ転位,Sb {111} 表面

9
H 0609 : 1999
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
写真22 OSF Sb {100} 表面
写真23 BMD Sb {100} へき開面
写真24 OSF Sb {111} 表面
写真25 BMD Sb {111} へき開面
写真26 スリップ転位,Sb {111} 表面
注(1) 明りょう(瞭)な結晶欠陥写真を得るため,エッチング時間を延長している。

10
H 0609 : 1999
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
4. 試料 試料は,次による。
a) 単結晶ウェーハ用 各結晶方位に対して傾き6°以内のウェーハで,スライス及びラップウェーハは,
5.3a)の化学研磨液でエッチングし表面を鏡面状にする。ただし,鏡面ウェーハには化学研磨は不要で
ある。
b) エピタキシャルウェーハ用 エピタキシャル成長したウェーハを用いる。
c) 熱酸化ウェーハ用 各種デバイスの製造工程の中で,熱処理に関係する工程に対応した熱酸化処理を
行った鏡面ウェーハを使用する。
例 ウェーハ表面だけの検査の場合は,ウェーハを10cm/minの速度で炉内に押し込み,800℃から4
〜10℃/分の割合で温度を上昇させ,1 000〜1 200℃の一定温度で1〜6時間の水蒸気酸化後,2〜5℃
/分の割合で800℃まで冷却し,10cm/minの速度で取り出したウェーハを使用する。
備考 熱酸化ウェーハ用の検査は,主として集積回路用などに使用される鏡面ウェーハの検査として
利用されている。表面欠陥の発生原因は,結晶に起因するもの以外に,加工ひずみ層,汚染,
鏡面加工又は洗浄によるものと,デバイス製造工程での損傷,熱ひずみ,汚染によるものなど
があるので注意を要する。
5. エッチング
5.1
エッチング環境 試料のエッチング時の周囲温度は23±3℃とする。
5.2
使用する薬品 使用する薬品は,表1による。
表1 使用する薬品
薬品
品位
濃度%
ふっ化水素酸
JIS K 8819に規定する特級又はこれと同等以上のもの。
49 〜 50
硝酸
JIS K 8541に規定する特級又はこれと同等以上のもの。
69 〜 71
酢酸
JIS K 8355に規定する特級又はこれと同等以上のもの。
99 〜 100
よう化カリウム JIS K 8913に規定する特級又はこれと同等以上のもの。
99.5〜 100
硝酸銀
JIS K 8550に規定する特級又はこれと同等以上のもの。
99.8〜 100
5.3
エッチング液
a) 化学研磨液 ふっ化水素酸3容,硝酸(濃度69〜71%)5容,酢酸3容を混合した溶液。
b) 選択エッチング液(I) 抵抗率0.02Ω・cmを超える高抵抗率のウェーハに用いる選択エッチング液の種
類は4種類とし,組成は表2による。4種類の選択エッチング液によって,検出する各種結晶欠陥の
関係とエッチング時間は,表3による。
表2 選択エッチング液(I)の組成(容積比)
液
ふっ化水素酸
硝酸
酢酸
水
A液
1
12.7
3
3.7
B液
1
12.7
3
5.7
C液
1
12.7
1
6.7
D液
2
12.7
2
6.7

11
H 0609 : 1999
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
表3 選択エッチング液(I)による各種結晶欠陥検出のエッチング時間
液
結晶欠陥の種類とエッチング時間 (min)
参考
備考
結晶転位
リネージ
エピタキシ
ャルSFな
ど
OSF
スリップ スワール
SF
ピットなど
BMD(へ
き開面)
シャロー
ピット
エッチング
速度化
(2)
A液
(3)
(3)
0.5〜1.5
2〜8
3〜6
1.5〜3
2〜8
1.3
より速い
かくはん
B液
15〜20
2〜6
1.5〜2
2〜8
4〜8
2 〜4
2〜8
0.6
面内均一良好
C液
(3)
(3)
1.5〜2
2〜8
4〜8
2 〜4
2〜8
0.9
BOD対策
D液
8〜15
2〜10
(3)
2〜8
(2)
(2)
2〜8
1.6
FZ結晶用
注(2) セコ液及びライト液を1とした場合の比率でジルトル液は2となる。
セコ液は,HF : K2Cr2O7 (0.15mol) =2 : 1で混合したもの。
ライト液は,HF60ml, HNO3 30ml, Cu(NO3)22g, CrO3(5mol)30ml, CH3COOH60ml及びH2O60mlを混合したも
の。
(3) エッチング時間を加減して検出する。
c) 選択エッチング液(II) 抵抗率0.02Ω・cm以下のウェーハに用いる選択エッチング液の種類は5種類
とし,組成,適用ウェーハは表4による。5種の選択エッチング液によって検出する各種結晶欠陥と
エッチング時間は,表5による。各種選択エッチング後の各種結晶欠陥の光学顕微鏡によるエッチピ
ット写真を写真11から写真26に示す。
表4 選択エッチング液(II)の組成(容積比)
適用ウェーハ
ドーパント,結晶面
液
ふっ化
水素酸
硝酸
酢酸
水
添加剤
試薬名:濃度
B {100}
E(4)
1
2.5
−
10.5 AgNO3 : 0.005mol/l(5)
F(4)
3
5.1
−
7.9
G
1
12.7
−
6.3
Sb {100}
Sb {111}
H
2
5.9
2
6.1 KI : 0.1〜0.5g/l(6)
I
2
6.8
2
6.2 KI : 0.1〜0.5g/l(6)
注(4) E液及びF液による選択エッチング後,ウェーハの表面にステイン膜が生じる。エッチ
ング後のウェーハを水洗した後,B液に5〜10秒浸せきすることでステイン膜は除去さ
れる。
(5) E液1l当たり濃度0.005mol/lの硝酸銀 (AgNO3) 水溶液を8ml添加することで,反応開
始時間を早める効果がある。
(6) H液,I液によう化カリウム (KI) を0.1〜0.5g/l添加することでステイン膜の生成は抑
制される。
表5 選択エッチング液(II)による各種結晶欠陥検出のエッチング時間
適用ウェーハ
ドーパント,結晶面
液
エッチング時間 (min) エッチング速度
(μm/min)
(片面)
備考
OSF, BMD(へき開面),
スリップ転位
B {100}
E
1〜3(7)
1.4〜3.3
添加剤は,エッチング直前に加える。
F
1〜3
1.1〜1.6
G
1〜3
1.3〜2.5
Sb {100}
H
1〜5
0.5〜1.8
エッチング速度は,KI濃度に依存する。
添加剤は,エッチング直前に加える。
I
1〜6
0.8〜1.9
注(7) 枚葉処理の場合は,ステイン膜がウェーハ全面に広がった時点でエッチングを終了する。
12
H 0609 : 1999
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
5.4
エッチング用の容器及び器具類 ウェーハホルダ及び容器は,ポリエチレン,ポリプロピレン,ポ
リ塩化ビニル,ふっ素樹脂製などとする。真空ピンセットの先端は,石英ガラス,炭化けい素,ふっ素樹
脂製などとし,ピンセットも樹脂材で被服したものを使用する。容器及び器具類は,汚染のないものを使
用する。
5.5
エッチング前処理
a) 単結晶ウェーハ用 スライス及びラップウェーハの場合は,ウェーハをウェーハホルダに収容し5.3a)
の化学研磨液に浸せきし,加工ひずみ層を除去するため片面50μm以上を溶解除去する。エッチング
中はホルダを上下左右に動かし反応を進行させる。その後,ウェーハホルダを急速に引き上げ水洗槽
に移し水洗する。鏡面ウェーハは,化学研磨なしで5.6の選択エッチングを行う(7)。
b) エピタキシャルウェーハ用 前処理なしで5.6の選択エッチングを行う。
c) 熱酸化ウェーハ用 ウェーハをウェーハホルダに収容し,ふっ化水素酸液に1分間以上浸せきし,酸
化膜を完全溶解除去する。その後,ウェーハホルダを急速に引き上げ,水洗槽に移し超純水で水洗す
る(8)。
5.6
選択エッチング エッチング前処理が終わったウェーハは,ウェーハホルダごと水洗槽から引き上
げ選択エッチング液に浸せきする。
液量は,ウェーハ表裏両面積1cm2当たり1.4ml以上とし,ウェーハ上端から3cm以上高い液面になるよ
うにする。エッチング中は反応が均一に進行するようにウェーハホルダを上下左右にゆっくり動かす。所
定時間後,ウェーハホルダを急速に引き上げて水洗槽に移し,超純水で水洗後,ろ過した空気,窒素ガス,
スピンナなどで乾燥する(8)。
注(8) 試料が1枚の場合は容器の底に試料の測定面を上にして置き,エッチング液を加えて作業を開始
する。反応促進のため容器を揺り動かし,所定時間後大量の超純水で希釈し,水洗する。
6. 測定
6.1
測定装置 測定装置は,倍率10倍の拡大鏡,50〜1 000倍の金属顕微鏡又は微分干渉顕微鏡を使用
する。
6.2
測定位置 測定位置は,次の8種類とする。
a) 測定位置は,図1 1)に示すオリエンテーションフラットに平行な直径上の外周から8mmの点及び中心
点の計3点(9)。
b) 測定位置は,図1 2)に示すオリエンテーションフラットに平行な直径上の外周から5mm,R/2,及び
中心点の計5点(9)。
c) 測定位置は,図1 3)に示すオリエンテーションフラットを基準にして,直交直径上の外周から5mm,
R/2,及び中心点の計9点(9)。
d) 測定位置は,図1 4)に示すオリエンテーションフラットを基準にし,外周部から5mmを除いた直交直
径上を顕微鏡の視野の幅で走査する(9)。
e) 図1 5)は,結晶面方位 {100} 面用及び {111} 面用の2種類の測定位置を示し,実線と点線とで区分
した。実線は,結晶面方位 {111} 面用の測定位置を示し,オリエンテーションフラット又はノッチの
垂直線に30°傾斜した直径と,これに直交する直径上。点線は結晶面方位 {100} 面用の測定位置を
示し,垂直線に45°傾斜した直交直径上を顕微鏡の視野の幅で走査する。ただし,結晶面方位 {100}
面用, {111} 面用とも,外周部5mmを除く。
f)
目視又は拡大鏡でウェーハ全面を観察し,最大密度と思われる点。

13
H 0609 : 1999
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
g) へき開面の測定位置は,へき開面の中央部。
h) へき開面の測定位置は,厚さの中心線上の外周から5mmと中心点の計3点。
注(9) オリエンテーションフラット,ノッチなど基準がない場合は,任意の直径を選ぶ。
図1 測定位置
6.3
測定方法,測定位置及び測定値の処置
6.3.1
転位
a) 測定方法 倍率100倍又は200倍の顕微鏡によってエッチピットを計測し,測定視野面積から個/cm2
に換算する。
b) 測定位置と測定値の処理方法 次のいずれかによる。
1) 6.2a) の測定位置による3点の計測値の平均値を個/cm2に換算する。
2) 6.2b) の測定位置による5点の計測値の平均値と,必要に応じて最大値をそれぞれ個/cm2に換算す
る。
6.3.2
リネージ周辺 2mmを除くウェーハ全面を目視によってリネージを検出し,拡大鏡を使用して,
それぞれの長さ及び本数を計測し,長さの総和を算出する。
6.3.3
スリップ 目視又は拡大鏡で外周部のスリップを検出し,それぞれの長さ及び本数を計測し,本数
と長さの総和を算出する。
6.3.4
スワール及び成長じま 目視によって有無を確認し,検出された場合は倍率100倍以上の顕微鏡に
よってしま状の線を観察し,不連続なピットの並び(スワール)か連続の線(成長じま)かを判定する。
6.3.5
積層欠陥(酸化誘起積層欠陥,エピタキシャル面) 積層欠陥の判定方法,測定位置及び測定値の
処理は,次による。
a) 測定方法
1) 倍率100倍又は200倍の顕微鏡で計測する。
14
H 0609 : 1999
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
2) 倍率100倍又は200倍の顕微鏡で走査し計測する。
b) 測定位置と測定値の処理方法
1) 6.2a)の3点の計測値の平均値と,必要に応じて最大値をそれぞれ個/cm2に換算する。
2) 6.2c)の9点の計測値の平均値と,必要に応じて最大値をそれぞれ個/cm2に換算する。
3) 6.2d)の全走査面積累計の平均値と,必要に応じて最大値をそれぞれ個/cm2に換算する。全走査面積
の累計は,顕微鏡の視野の幅と走査距離の積によって算出する。
4) 6.2e)の全走査面積累計の平均値と,必要に応じて最大値をそれぞれ個/cm2に換算する。
5) 6.2f)の最大密度の点を計測し,個/cm2に換算する。
6.3.6
シャローピット シャローピットの測定方法及び測定値の処理は,次による。
a) 測定方法 直径20〜40mmの光束で光源から100mmの点の照度が16lx以上になる集光灯を使用し,
その絞りを開いてウェーハ上にフィラメントの像が結ぶ距離で照光し,反射光を避けて観察する。
なお,倍率400〜1 000倍の顕微鏡によってシャローピットか否かを判定する。
h) 測定値の処理方法
1) 形状を確認する(例えば,リング状,ディスク状など)。
2) ウェーハ面積に対してシャローピットの占める面積比(パーセント)を算出する。
6.3.7
内部微小欠陥 内部微小欠陥の測定方法,測定位置及び測定値の処理は,次による。
a) 測定方法 倍率100〜1 000倍の顕微鏡で積層欠陥及びピットを計測する。
b) 測定位置と測定値の処理方法 次のいずれかによる。
1) 6.2g)の測定位置の計測値を個/cm2に換算する。
2) 6.2h)の測定位置の3点の計測値の平均と最大値をそれぞれ個/cm2に換算する。
6.3.8
無欠陥層 測定方法,測定位置及び測定値の処理方法は,受渡当事者間の協定による。
7. 報告書の作成 報告書の記載事項は,受渡当事者間の協定によるが,対応欠陥名称,使用する選択エ
ッチング液の種類,エッチング時間,測定位置及び顕微鏡倍率は,必ず記載する。
15
H 0609 : 1999
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
JIS改正原案作成委員会 構成表
氏名
所属
(委員長)
三 木 克 彦
信越半導体株式会社
垂 井 康 夫
早稲田大学
田 中 良 昭
エム・イー・エム・シー株式会社
松 本 宗 之
沖電気工業株式会社
中 井 康 秀
株式会社神戸製鋼所
永 井 清 司
コマツ電子金属株式会社
薬師寺 健 次
昭和電工株式会社
北川原 豊
信越半導体株式会社
音 川 孝 雄
信越半導体株式会社
宮 崎 守 正
住友金属工業株式会社
河 野 勝 巳
ソニー株式会社
土 屋 憲 彦
株式会社東芝
桐 野 好 生
東芝セラミックス株式会社
瀧 川 家 光
ニッテツ電子株式会社
堀 川 貢 弘
日本電気株式会社
松 田 安 司
株式会社日立製作所
金 田 寛
株式会社富士通研究所
大 石 博 司
松下電子工業株式会社
吉 田 佳 子
三菱電機株式会社
木 村 泰 広
三菱電機株式会社
河 合 健 一
三菱マテリアルシリコン株式会社
小 山 浩
日本電子株式会社
(事務局)
大 塚 豊
社団法人日本電子工業振興協会
木 暮 英 男
社団法人日本電子工業振興協会
JIS改正原案作成分科会 構成表
氏名
所属
(主査)
宝 来 正 隆
住友金属工業株式会社
真 島 正 樹
信越半導体株式会社
杉 山 栄 人
エム・イー・エム・シー株式会社
伊 藤 眞 宏
沖電気工業株式会社
亀 井 雄次郎
コマツ電子金属株式会社
大 王 宏
昭和電工株式会社
竹 田 隆 二
新潟東芝セラミックス株式会社
瀧 川 家 光
ニッテツ電子株式会社
堀 川 貢 弘
日本電気株式会社
和 田 貴 幸
富士通株式会社
大 石 博 司
松下電子工業株式会社
吉 田 佳 子
三菱電機株式会社
木 村 泰 広
三菱電機株式会社
吉 岡 秀 雄
三菱マテリアルシリコン株式会社
河 合 健 一
三菱マテリアルシリコン株式会社
(事務局)
木 暮 英 男
社団法人日本電子工業振興協会